RTN et recuit liés aux contraintes et à la température dans le tableau FIND RRAM
Résumé
Dans ce travail, une observation sur le signal de bruit télégraphique aléatoire (RTN) dans le courant de lecture d'un dispositif RRAM diélectrique FinFET (FIND RRAM) est présentée. On constate que le signal RTN d'une cellule FIND RRAM change après que le dispositif a été soumis à une contrainte de cyclage. Après avoir subi un stress cyclique, les cellules RRAM ont une tendance plus forte à montrer des signaux RTN plus fréquents et plus intenses. L'augmentation des niveaux de bruit dans les cellules FIND RRAM peut être généralement atténuée par un recuit à haute température, et avec ce concept, un schéma de recuit sur puce est proposé et démontré.
Introduction
La mise à l'échelle continue de la technologie CMOS a considérablement amélioré les caractéristiques et les performances des circuits intégrés au cours de la dernière décennie. Cependant, à mesure que le nœud technologique est réduit en dessous de 20 nm, les variations dues à un seul atome/électron dans les caractéristiques du dispositif augmentent, par exemple, les fluctuations aléatoires du dopant (RDF), et soulèvent ainsi des problèmes fondamentaux qui ne peuvent pas être surveillés [1]. Par exemple, toute variation du nombre de porteurs ou de défauts structurels a un impact beaucoup plus important sur la sortie et les performances d'un dispositif mis à l'échelle, et les effets de la mise à l'échelle du dispositif sur la variabilité due au RDF et à la rugosité des bords de la grille (LER) ont également été rapporté [2,3,4]. Le bruit télégraphique aléatoire (RTN) est considéré comme un autre défi majeur pour les appareils de petite surface, tels que les flashs NAND et les RRAM [5,6,7,8,9,10,11]. Dans ce travail, nous étudions le bruit RTN dans une cellule FIND RRAM FINFET à canal n, qui a déjà été implémentée avec succès dans un processus logique standard dans des tableaux de 1kbit [12]. Des changements dans le RTN en réponse aux contraintes de cyclage et à la cuisson à haute température sont observés. Dans ce travail, les effets du stress et de la température sur le bruit RTN dans les cellules FIND RRAM sont étudiés et un schéma de recuit sur puce est proposé pour atténuer le bruit de courant de lecture variant dans le temps après le cycle.
Contexte et méthodes
Une RRAM FIND se compose de deux transistors FinFET. L'un agit comme le transistor de sélection WL en série du nœud RRAM. Le diélectrique de grille à k élevé entre le SiP et le SL de l'autre transistor sert de nœud de stockage, comme le montre la figure 1a. Les dispositifs FIND se composent du film diélectrique de grille dans les FinFET standard, où l'électrode de grille est W pour l'électrode supérieure et TaN pour le bas. L'oxyde de la pile de grille est constitué de HfO2 /SiO2 /Couches d'empilement TiN [12]. La condition de lecture d'une cellule FIND RRAM est illustrée sur la figure 1b, où WL reçoit 0,8 V pour activer le transistor de sélection, tandis que 0,8 V est ajouté à SL afin de générer un courant de lecture suffisant pour la lecture des données. La commutation résistive entre les états d'état à haute résistance (HRS) et d'état à faible résistance (LRS) est obtenue en effectuant un réglage/réinitialisation sur la cellule FIND RRAM [13]. Une RRAM FIND montre des caractéristiques de commutation résistive assez stables sous des balayages CC, voir Fig. 2a, tandis que ses caractéristiques de temps de réglage et de réinitialisation sont résumées à la Fig. 2b. Les conditions de fonctionnement énumérées sur la figure 2a montrent que des fonctionnements à basse tension sont possibles. Les cellules subissent plusieurs cycles d'impulsions à la fois pour le réglage et la réinitialisation afin d'atteindre les niveaux de courant de lecture ciblés. La largeur d'impulsion augmentera si l'appareil ne parvient pas à se régler ou à se réinitialiser après l'application de plusieurs impulsions, comme illustré à la Fig. 3a. Un signal RTN distinctif peut être trouvé dans les cellules LRS et HRS FIND RRAM, comme le montre la figure 3b. Les signaux RTN provoqués par le piégeage et le dépiégeage de charge dans le chemin conducteur de courant peuvent entraîner une fluctuation importante du courant [14,15,16,17].
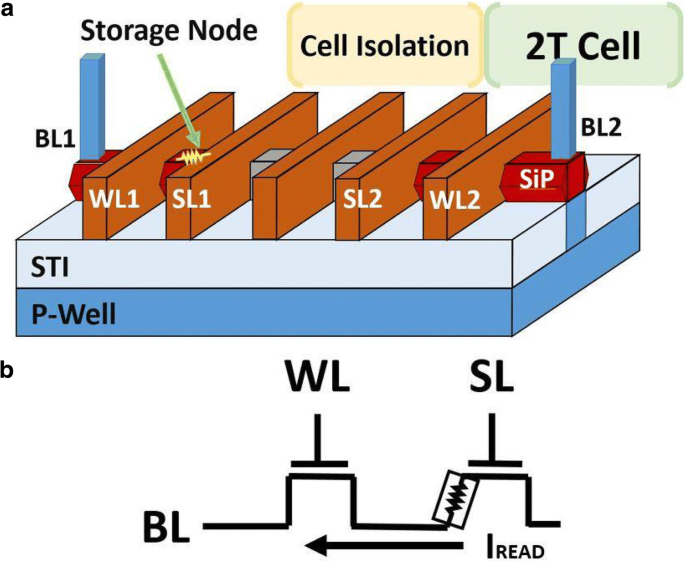
un Illustration 3D des cellules 2 T FIND RRAM implémentées par les technologies CMOS FinFET et b le schéma de circuit d'une cellule unitaire pour FIND RRAM en condition de lecture est affiché, où VSL =VWL =0,8 V et BL est polarisé à zéro
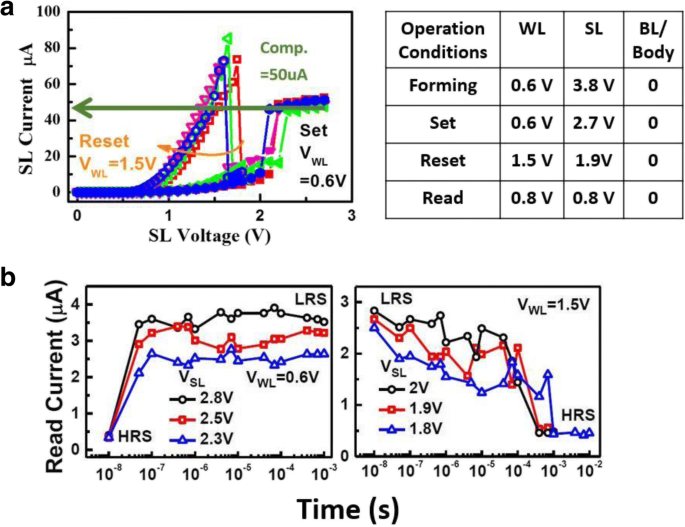
Les caractéristiques de commutation résistive CC de la RRAM FIND et ses conditions de fonctionnement sont indiquées dans (a ). Ses caractéristiques de temps de réglage et de réinitialisation sont résumées dans (b )

un Illustration de la largeur d'impulsion croissante utilisée pour effectuer l'opération de réglage/réinitialisation. Après la première impulsion de 1 μs, une opération de lecture est effectuée pour évaluer si le courant de lecture atteint les niveaux cibles de 3 μA pour LRS et de moins de 1 μA pour HRS. Si l'état requis n'est pas atteint, l'impulsion suivante est donnée. La largeur d'impulsion est prolongée d'un ordre toutes les dix impulsions. b Comparaison du courant de lecture à température ambiante échantillonné à VSL =VWL =0,8 V et VBL =0, avec un taux d'échantillonnage de 500 Hz, avant et après avoir effectué 100 cycles
Il est bien établi que le cycle répété, c'est-à-dire la commutation entre les deux états, peut induire une contrainte sur la couche diélectrique de grille FinFET [18]. La couche d'oxyde de métal de transition (TMO) sollicitée dans les cellules FIND RRAM a une tendance plus forte à afficher des bruits RTN, ce qui entraîne un courant de lecture variable dans le temps qui peut entraîner des erreurs de lecture et des problèmes de stabilité lors de la lecture des données. Dans cette expérience, nous avons échantillonné les courants de lecture de la matrice à frais, après 10x cycles et après 100x cycles, afin d'observer l'effet de contrainte sur RTN dans la FIND RRAM.
Pour étudier l'effet de la température sur les cellules FIND RRAM stressées, des échantillons avec des signaux RTN distincts dans le LRS sont d'abord refroidis à 0 °C, puis progressivement chauffés jusqu'à 50 °C. Au cours de ce processus, les courants de lecture à ces températures sont échantillonnés en continu pendant 20 s à une fréquence de 500 Hz. Cela nous donne une idée de la façon dont le RTN se comporte en cas de changement de température.
Résultats et discussion
Grâce à des mesures approfondies, il a été constaté que RTN est plus stable et facilement observable dans une cellule FIND RRAM au niveau de son LRS. Par conséquent, dans l'étude de l'effet de cyclage et de recuit sur la RTN des cellules FIND RRAM, la section suivante se concentre sur l'étude des cellules au LRS. Comme le montre la figure 4a, les bruits RTN entraînent un courant de lecture variant dans le temps, ce qui provoque une erreur de lecture. Cet effet peut être observé dans le réseau de cellules de 1kbit. Dans un réseau qui a subi 10 cycles, des fluctuations importantes du courant de lecture sont détectées lors de l'échantillonnage du courant de lecture pendant un intervalle de 20 s. La carte de courant binaire normalisée dans un réseau est présentée sur la figure 4b, où les fluctuations de courant dans le LRS peuvent atteindre + 5 %, ce qui est comparable au RTN observé dans le courant de fuite de grille après contrainte [19]. Pour étudier l'effet du stress, nous avons suivi les niveaux de fluctuation actuels de 50 cellules avant et après le cycle de stress. Les données de la figure 5a révèlent que plus de 90 % des cellules présentent une augmentation de ΔI/I après le cycle. À savoir, le bruit variant dans le temps dans la FIND RRAM s'aggrave progressivement à mesure que les cellules subissent plus de contraintes de cyclage. Lorsque nous comparons la distribution de courant de lecture normalisée des cellules fraîches et des cellules cyclées, on constate que les cellules qui ont traversé plus de cycles présentent des signaux RTN plus significatifs et présentent deux distributions de courant de crête ou plus à des états particuliers. D'un autre côté, les cellules fraîches ont une distribution actuelle d'une distribution standard, suggérant qu'il n'y a pas de bruits RTN impliqués dans la fluctuation, comme le montre la figure 5b [20, 21]. Cela suggère qu'une fois qu'une RRAM FIND subit une contrainte de cycle long, son courant de cellule binaire peut être soumis à des fluctuations plus drastiques en raison de l'ajout de RTN.

un Un courant de lecture normalisé à 25 °C échantillonné à une fréquence de 500 Hz dans une cellule RRAM ayant subi 10 cycles. Cela montre que RTN provoque un courant de lecture variant dans le temps. b Affiche le tracé du courant normalisé dans un tableau de 1 kbit ayant subi 10 cycles, échantillonné simultanément à t1 = 3, t2 = 7,5, t3 = 14 et t4 = 17,5 s, de manière séquentielle. En comparant l'instantané à différents moments, le courant de lecture fluctue dans les mêmes conditions de lecture

un Comparaison de la distribution des |ΔI/I| de 50 échantillons avant et après stress. On peut voir que les cellules présentent un ΔI/I globalement plus grand après stress. Les valeurs centiles de la boîte à moustaches de bas en haut représentent respectivement les 25, 50 et 75 points centiles, tandis que les moustaches indiquent les valeurs maximales et minimales. b Histogramme de la distribution de courant de lecture normalisée d'une cellule mesurée à l'état frais et après 10 et 100 cycles. Cela montre qu'une fois qu'une RRAM FIND subit une contrainte de cycle long, son courant de cellule binaire peut être soumis à des fluctuations plus drastiques en raison de l'ajout de RTN
Les résultats normalisés de l'échantillon de courant lu à différentes étapes de température sont comparés sur la figure 6. Le temps de capture et le temps d'émission des pièges RTN ont été étudiés et sont connus pour changer avec la température, qui diminuent tous les deux à mesure que la température augmente [22, 23 ]. Comme prévu, la fréquence du bruit RTN augmente à mesure que la température augmente, à savoir que les fluctuations du courant de lecture à 0 °C se produisent moins fréquemment qu'à 25 °C. Cependant, lorsqu'elles sont mesurées à 50 °C, les fluctuations de courant entre deux états deviennent moins importantes. Cela peut être davantage révélé sur la figure 7a, qui trace l'histogramme des courants de lecture normalisés mesurés à 0 °C, 50 °C et à la température ambiante. Les distributions de courant de 0 °C et 25 °C ont deux pics de distribution, suggérant des états de piégeage simples RTN dominant le chemin conducteur [19], tandis que les états discrets sur le courant échantillonné à 50 °C deviennent moins importants. Cela suggère qu'à une température plus élevée, les pièges à l'origine du signal RTN pourraient être sujets à une instabilité telle qu'un effet de recuit ou une recombinaison de défauts, affectant par conséquent la probabilité de piégeage des électrons et facilitant ainsi l'effet RTN [27].

Une comparaison des courants de lecture normalisés d'une cellule RRAM (à l'état LRS) ayant subi 100 cycles avec un bruit RTN mesuré à 0, 25 et 50 °C, à une fréquence d'échantillonnage de 500 Hz

un Une comparaison des histogrammes de la distribution du courant de lecture normalisé d'une cellule dans l'état LRS mesuré à 0, 25 et 50 °C. b Une comparaison de la probabilité cumulée du |ΔI/I| de 30 échantillons avant contrainte, après contrainte et après recuit, respectivement. On constate qu'une grande partie des cellules retourne à son ΔI/I d'origine après le processus de recuit
Dans une étude plus approfondie, les échantillons sont chauffés jusqu'à 75 °C. Ces cellules ont refroidi à température ambiante après 30 min, puis les échantillons sont prélevés. Trente cellules sont choisies et leurs niveaux de fluctuation de courant cumulés à frais, stressés et après recuit sont comparés sur la figure 7b. Cela montre que la plupart des cellules retournent à leur ΔI/I d'origine après le processus de recuit. Les courants de lecture normalisés d'une cellule à l'état frais, à l'état stressé et après cuisson sont comparés sur la figure 8. Le courant après cuisson ressemble à celui qui est frais, suggérant que la cuisson à haute température recuit les pièges qui provoquent les signaux RTN. La figure 9a est un tracé organisé du courant de lecture normalisé pour un tableau de 1 kbit de cellules fraîches, de cellules légèrement stressées, de cellules très stressées et après la cuisson, respectivement. À partir du tracé, il est démontré que les fluctuations de courant deviennent plus intenses lorsque la RRAM est fortement sollicitée et sont considérablement réduites après la cuisson à haute température. Cet effet peut être observé dans l'ensemble du réseau, ce qui confirme que la cuisson à haute température fournit en fait un effet de recuit aux pièges qui induisent le bruit RTN [24,25,26,27,28,29]. La figure 9b compare en outre les distributions ΔI/I dans une matrice de cellules obtenues par dix échantillonnages différents séquentiellement. On constate que le même réseau présente des distributions ΔI/I différentes dans ses états frais, de contrainte et après recuit. Les données suggèrent que le recuit aide le réseau de cellules à montrer des fluctuations de courant réduites, similaires au niveau d'un réseau à l'état frais. Ce résultat peut être utilisé pour corriger et prolonger la durée de vie des cellules FIND RRAM qui ont présenté des signaux RTN après un cycle de stress.

Courants de lecture de cellules fraîches et stressées échantillonnées à 25 °C, 500 Hz par rapport à celle de la cellule après cuisson à haute température et refroidie dans une période de 30 min à température ambiante. Il montre qu'après la cuisson, le stress est soulagé et la cellule se comporte comme une cellule fraîche

un Courants de lecture normalisés d'un réseau de 1 kbit pris à un instant spécifique tracés à l'état frais, légèrement sollicité, fortement sollicité et après recuit. On peut voir que le nombre de cellules avec une forte fluctuation augmente considérablement dans le réseau à mesure que le réseau subit plus de stress et meurt après son recuit. b Comparaison des probabilités cumulées des |ΔI/I| distributions de 50 échantillons du même réseau dans ses états frais, stressé et après recuit, à différents moments avec un intervalle de 1 s. Le ΔI/I global sur les échantillons après contrainte est plus élevé, et il revient à la normale après recuit
Il convient de mentionner que certaines cellules bloquées dans un état moyen pendant le cycle sont régénérées après un traitement à haute température. Lorsqu'une cellule FinFET RRAM parcourt LRS et HRS, le filament conducteur de certaines cellules peut former un canal qui ne peut pas être réinitialisé facilement. Le processus de cuisson fournit à ces cellules un chemin pour redistribuer ses lacunes en oxygène, permettant ainsi une réinitialisation efficace à HRS [30]. La figure 10 montre qu'une cellule qui n'a pas pu passer en HRS est réactivée après 125 °C, 15 min de cuisson. Dans cet esprit, un mécanisme de recuit sur puce impliquant le chauffage local de la cellule FIND RRAM est proposé. Un courant constant de 1,5 mA avec une période de 10 s est appliqué à la cellule via une polarisation directe à la jonction de drain du FinFET sélectionné, comme illustré sur la figure 11a. Ce courant important chauffe une région confinée près de la RRAM TMO et produit un effet de recuit similaire. Le courant de lecture avant et après recuit du dispositif sous test (DUT) est mesuré et analysé sur la Fig. 11b. Les distributions cumulatives du courant de lecture échantillonné en continu démontrent l'élimination de RTN sur une cellule après l'étape de recuit sur puce. Ici, le recuit sur puce de la RRAM FIND a été effectué sur des cellules individuelles par étapes séquentielles pour comprendre la réponse nominale à une cellule RRAM typique après contrainte. Une nouvelle procédure de recuit sur puce doit être développée pour une expérience au niveau de la matrice.

En appliquant une cuisson à 125 °C aux cellules qui sont bloquées dans un état intermédiaire et en fournissant un processus de recuit, nous reconvertissons ces cellules en état fonctionnel, prolongeant ainsi la durée de vie des cellules

Le schéma de recuit sur puce que nous avons proposé implique l'application de − 1 V à BL résultant en une polarisation directe et un courant mesuré de 1,5 mA, qui chauffe et recuit la cellule sollicitée. Dans le graphique, en comparant le pourcentage cumulé du courant normalisé de la cellule avant et après le processus, nous pouvons voir que la fluctuation de courant causée par RTN est considérablement réduite
Conclusion
Dans cet article, l'effet du stress et de la température sur le RTN dans le réseau de cellules FIND RRAM est discuté. Une augmentation de la RTN induite par le stress cyclique est observée. L'effet du traitement à haute température sur la réduction de la RTN et le soulagement du stress pour la TMO dans une RRAM FIND est observé. Enfin, un schéma de recuit sur puce est proposé et démontré.
Abréviations
- TROUVEZ RRAM :
-
Mémoire vive diélectrique résistive à transistors à effet de champ à ailettes
- HRS :
-
État de haute résistance
- LER :
-
Rugosité des bords de ligne
- LRS :
-
État de faible résistance
- RTN :
-
Bruit télégraphique aléatoire
- TMO :
-
Oxyde de métal de transition
Nanomatériaux
- Contrôle d'accès avec QR, RFID et vérification de la température
- Capteur de température Python et Raspberry Pi
- Température et humidité faciles sur Raspberry Pi
- DIY :surveillance et régulation de la température pour HomeBrew
- Capteur de température et de luminosité Raspberry Pi
- Matériaux :Conseils de recuit pour les polymères amorphes, partie 2
- Mesure de la température à l'intérieur des composites et des lignes de liaison
- Qu'est-ce que le recuit ? - Définition, processus et étapes
- Capteur de débit et de température de laboratoire sur puce



