Diode Schottky β-Ga2O3 haute tension avec terminaison de bord implantée d'argon
Résumé
Les terminaisons Au/Ni/β-Ga2 O3 Des diodes à barrière Schottky ont été fabriquées en utilisant une implantation d'argon pour former les couches à haute résistivité à la périphérie des contacts d'anode. Avec une énergie d'implantation de 50 keV et une dose de 5 × 10 14 cm −2 et 1 × 10 16 cm −2 , la tension de claquage inverse passe de 209 à 252 et 451 V (le maximum jusqu'à 550 V) et la figure de mérite de Baliga (VBR 2 /Ron ) augmente également de 25,7 à 30,2 et 61,6 MW cm −2 , environ 17,5% et 140% d'amélioration, respectivement. Selon la simulation 2D, les champs électriques au coin de jonction sont lissés après implantation d'argon et la position du champ électrique de claquage maximal, 5,05 MV/cm, passe du coin anodique à l'interface au coin de recouvrement juste sous l'implantation Région. La dépendance à la température des caractéristiques directes a également été étudiée.
Contexte
Développement de dispositifs haute puissance utilisant des matériaux semi-conducteurs à ultra-large bande interdite tels que Ga2 O3 , AlN, diamant, etc. s'accélère ces dernières années. La bande interdite de β-Ga2 O3 est aussi grand que 4,8-4,9 eV et le champ de claquage de β-Ga2 O3 est estimée à 8 MV/cm, environ trois fois plus grande que celle du 4H-SiC et du GaN. Le facteur de mérite de Baliga, 3400, est au moins dix fois supérieur à celui du 4H-SiC et quatre fois supérieur à celui du GaN [1]. De plus, le grand monocristal et le β-Ga2 à faible coût O3 le substrat peut être fabriqué avec des méthodes de croissance en fusion telles que la zone flottante (FZ) [2] et la croissance alimentée par film défini par les bords (EFG) [3, 4]. La densité électronique peut être contrôlée sur une large plage de 10 16 à 10 19 cm −3 par dopage avec Sn, Si ou Ge [5,6,7]. Ces excellentes propriétés font du β-Ga2 O3 idéal pour les applications de commutation haute tension et à faible perte, y compris la diode à barrière Schottky à tension de claquage élevée (SBD) et le transistor à effet de champ métal-oxyde-semiconducteur (MOSFET) [8,9,10,11,12] . Les diodes à barrière Schottky présentent les avantages d'une vitesse de commutation rapide et d'une faible chute de tension directe par rapport à la diode à jonction p-n, ce qui peut réduire la perte de puissance et améliorer l'efficacité des alimentations.
Bien que de grandes tensions de claquage de 1016 V, 2300 V et 1600 V aient été obtenues dans le β-Ga2 O3 Diodes à barrière Schottky sans terminaison de bord, elles représentent toutes environ 34 %, 8 % et 10 % de la valeur idéale [10, 13, 14]. Pour soulager l'effet d'encombrement du champ électrique et réaliser pleinement le potentiel de tension de β-Ga2 O3 , des terminaisons de bord appropriées doivent être conçues. Il existe un certain nombre de techniques de terminaison de bord pour augmenter la tension de claquage du dispositif, telles que les plaques de champ, les anneaux métalliques flottants, la structure MOS en tranchée, les anneaux de garde implantés et l'extension de terminaison de jonction (JTE) [12, 15, 16, 17]. Cependant, les anneaux de garde implantés et la structure JTE ne sont pas applicables au Ga2 O3 Diode Schottky en raison de l'absence de dopage de type p. H. Matsunami et BJ Baliga ont proposé une structure de terminaison de bord, utilisant l'implantation d'argon pour former une couche amorphe à haute résistivité aux bords de l'anode, afin de réduire l'encombrement du champ électrique [18,19,20,21,22], qui est une technique simple sans étapes de multi-photolithographie ou de gravure de tranchées profondes requises, et elle est largement utilisée dans les redresseurs SiC et GaN pour lisser la distribution du champ électrique autour de la périphérie du contact de redressement [15, 23, 24].
Dans cet article, le -Ga2 terminé par un bord vertical O3 Des diodes Schottky ont été fabriquées avec une implantation d'argon sur les bords des contacts Schottky. Les caractéristiques capacité-tension (C-V) et densité de courant-tension (J-V) dépendantes de la température ont été enregistrées à l'aide du système de caractérisation des semi-conducteurs Keithley 4200 et la distribution du champ électrique a également été analysée.
Méthodes/Expérimental
La couche de dérive d'une épaisseur de 10 μm a été obtenue à partir de β-Ga2 orienté Sn de haute qualité (100) orienté O3 substrat en vrac par exfoliation mécanique. Le -Ga2 O3 la masse a été cultivée par la technique EFG avec du Ga2 pur 4 N O3 poudre comme matière première. L'excellente qualité des cristaux et la surface lisse ont été confirmées par des mesures de diffraction des rayons X à haute résolution (HRXRD) et de microscope à force atomique (AFM), comme le montrent les figures 1a, b. La pleine largeur à mi-hauteur (FWHM) et la moyenne quadratique (RMS) ont été estimées à 37,4 arcsec et 0,203 nm, respectivement. La figure 1c montre la distribution de -Ga2 O3 résistance de la feuille du substrat d'une épaisseur de 10 μm par une mesure de sonde à quatre points. Utilisation d'une concentration de porteurs de (1,3 ± 0,04) × 10 17 cm −3 et une résistance de couche de (563 ± 18,5)Ω/□, la mobilité des électrons est calculée comme étant de 85,3~95,2 cm 2 /Vs par μn = 1/(RFeuille × n × q × t ), où n, Feuille R, n , q , et t sont la mobilité électronique, la résistance de couche, la concentration électronique, la charge électronique et l'épaisseur de β-Ga2 O3 substrat, similaire aux résultats rapportés [25]. Implantation d'ions argon avec une énergie de 50 keV, la dose de 2,5 × 10 14 cm −2 , et recuit à haute température à 950 °C pendant 60 min dans N2 atmosphère ont d'abord été effectuées sur la face arrière, suivies d'une évaporation par faisceau électronique d'un empilement de métal ohmique Ti/Au (20 nm/100 nm) et d'un recuit thermique rapide à 600 °C pendant 60 s dans N2 ambiant. Ensuite, la résine photosensible de 2 μm d'épaisseur a été utilisée comme masque pour l'implantation d'argon à température ambiante avec une énergie de 50 keV et la dose de 5 × 10 14 cm −2 (échantillon B) et 1 × 10 16 cm −2 (échantillon C), respectivement. Afin de réparer les dommages d'implantation et de réduire le courant de fuite sous polarisation inverse, les échantillons implantés ont été soumis à un recuit thermique rapide à 400 °C pendant 60 s sous N2 ambiant [13, 26]. Enfin, les électrodes d'anode circulaire Schottky d'un diamètre de 100 μm ont été fabriquées sur la face avant par un motif photolithographique standard, l'évaporation de l'empilement Ni/Au (30 nm/200 nm) et le décollage. Le dispositif de référence sans implantation d'argon a également été fabriqué (échantillon A). La figure 2a illustre la MET en coupe de Ga2 fabriqué O3 Diode Schottky avec terminaison de bord implantée d'argon. Un β-Ga2 amorphe presque en surface O3 couche a été créée dans la région d'implantation. La photographie réelle du -Ga2 terminé O3 La diode Schottky est illustrée à la Fig. 2b. La figure 2c représente la configuration de mesure du courant-tension direct (I -V ) caractéristiques du -Ga2 O3 SBD, tandis que la tension de mesure est comprise entre 0 et 3 V et le pas est de 10 mV. La figure 2d illustre la configuration de mesure du courant-tension inverse (I -V ) caractéristiques du -Ga2 O3 redresseurs Schottky pour obtenir la tension de claquage, tandis que la tension de mesure est comprise entre 0 et − 500 V et le pas est de − 1 V.

un Courbe de bascule XRD et b Image AFM du -Ga2 O3 couche de dérive exfoliée mécaniquement à partir de (100) β-Ga2 O3 substrat c résistance de feuille mesurée de 10 mm × 10 mm β-Ga2 O3 substrat
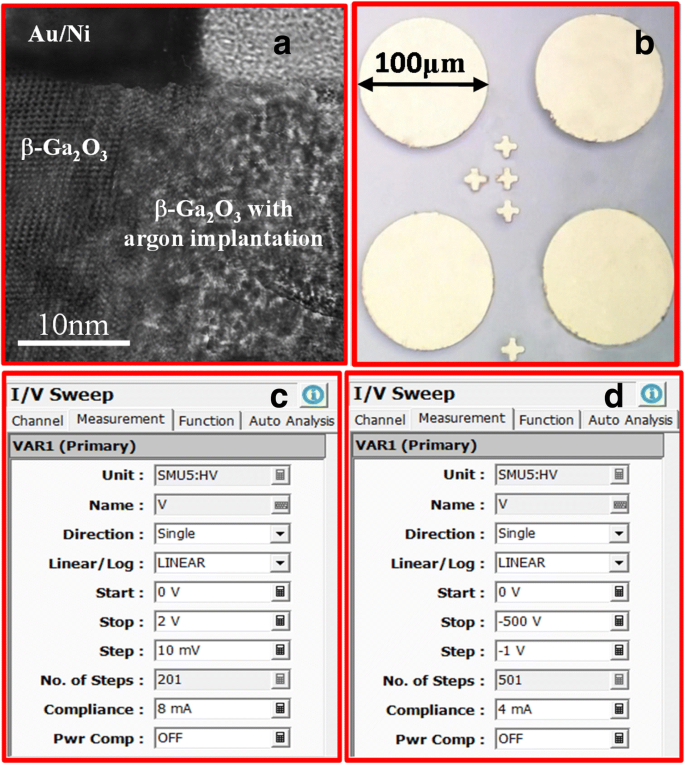
un Image MET de l'échantillon C et b photographie du β-Ga2 terminé O3 Diode Schottky c la configuration de mesure du courant direct et d caractéristiques courant-tension inverse (I-V) du -Ga2 O3 SBD pour obtenir la tension de claquage
Résultats et discussion
La figure 3 montre le 1/C expérimental 2 contre V caractéristiques de trois échantillons de SBD à température ambiante. La concentration effective de porteurs N d -N un de -Ga2 O3 couche de dérive et potentiel intégré (eV bi ) sont extraits pour être (1,3 ± 0,04) × 10 17 cm −3 et (1,30 ± 0,08) eV, respectivement. D'après les équations suivantes, la hauteur de barrière Schottky φ b_CV est calculé comme étant (1,32 ± 0,08) eV.
$$ \frac{1}{C^2}=\frac{2}{q\varepsilon {A}^2\left({N}_d-{N}_{\mathrm{a}}\right)} \left({V}_{bi}-V\right) $$ (1) $$ e{\varphi}_b={eV}_{bi}+\left({E}_c-{E}_f\ right)-e\Delta \varphi $$ (2) $$ {E}_c-{E}_f=kT\ln \left(\frac{N_c}{N_d-{N}_a}\right) $$ ( 3) $$ e\Delta \varphi ={\left\{\frac{e}{4\pi \varepsilon}{\left[\frac{2{eV}_{bi}\left({N}_d- {N}_a\right)}{\varepsilon}\right]}^{1/2}\right\}}^{1/2} $$ (4)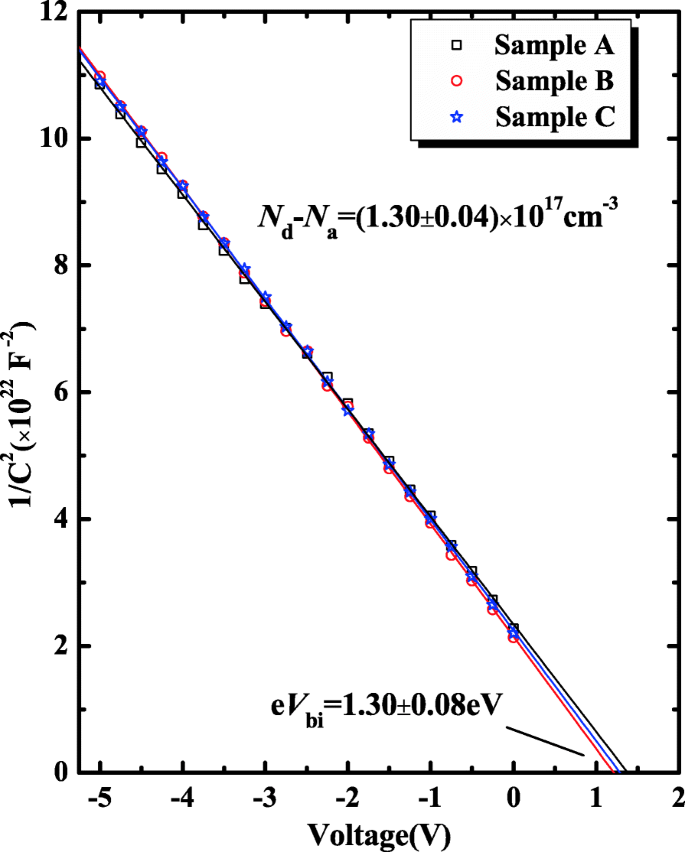
1/C 2 -V parcelles de trois β-Ga2 O3 Échantillons SBD
où A , q , et ε sont la zone de contact Schottky, la charge électronique et la permittivité de β-Ga2 O3 . E c , E f , eΔφ , k , T , et N c sont respectivement le minimum de la bande de conduction, le niveau de Fermi, l'abaissement de la barrière potentielle causé par la force d'image, la constante de Boltzmann, la température absolue en K et la densité effective d'états de la bande de conduction.
La figure 4a représente la tension de densité de courant directe (J -V ) caractéristiques du -Ga2 O3 SBD. Sous la polarisation directe, l'implantation d'argon n'a pas d'effet significatif sur les caractéristiques électriques. La tension de seuil est déterminée à 0,91 V, 0,92 V et 0,95 V pour trois échantillons, le I sur /Je désactivé les ratios sont tous supérieurs à 10 9 à température ambiante et en ajustant la région linéaire, les résistances passantes spécifiques (R sur ) sont de 1,7,2,1 et 3,3 mΩ cm 2 , et les densités de courant direct à 2 V sont de 857, 699 et 621 A/cm 2 pour trois échantillons, respectivement, comme le montre l'encart de la Fig. 4a. Les densités de courant sont plus élevées et les résistances à l'état passant spécifiques sont inférieures ou comparables aux valeurs rapportées pour la conductivité et la densité de porteurs plus élevées dans la couche de dérive [12, 13, 26,27,28,29,30].
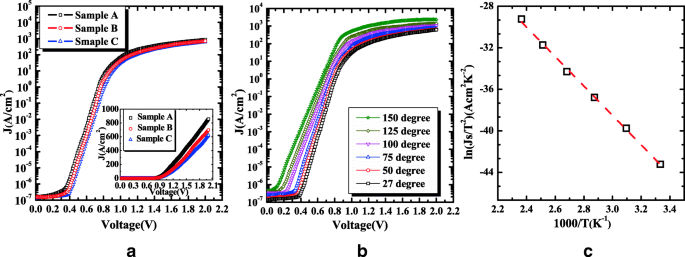
un L'avant J -V caractéristiques du -Ga2 terminé et non terminé O3 à température ambiante et b l'avance dépendant de la température J -V caractéristiques de l'échantillon C de 300 à 423 K. c L'intrigue de Richardson de ln(J s/T 2 ) vs 1000/T de l'échantillon C
Afin d'étudier les effets de l'implantation d'argon sur la dépendance à la température des caractéristiques directes, le J direct -V les mesures de l'échantillon C sont effectuées de 300 à 423 K, comme le montre la figure 4b. Le facteur idéal n et hauteur de barrière Schottky φ b_JV sont déterminés à 1,06 et 1,22 eV à température ambiante, inférieurs à la φ b_CV de (1,32 ± 0,08) eV, selon le modèle d'émission thermoionique (TE) [31, 32]. Avec l'augmentation de la température, le n diminue de 1,06 à 1,02 et la hauteur de la barrière diminue légèrement mais est presque constante à 1,21 ± 0,01 eV sur la plage de température, ce qui est contraire à la diminution de la hauteur de la barrière d'une diode Schottky idéale avec l'augmentation de la température mais a été observée dans le β-Ga fabriqué 2 O3 SBD [26]. En utilisant l'équation ln(J s/T 2 ) = ln(A*)-qϕ b /kT , la hauteur de barrière ϕ b et la constante de Richardson effective A* sont déterminées à 1,22 eV et 48,5 A/cm 2 K 2 pour l'échantillon C de la pente et du y -interception de l'axe de la région linéaire du tracé, comme le montre la figure 4c. De plus, les valeurs A* extraites pour des dizaines d'appareils sur les trois échantillons sont comprises entre 24 et 58 A/cm 2 K 2 , conforme aux résultats de l'expérience précédente et à la valeur théorique :24 à 58 A/cm 2 K 2 , avec la masse effective d'électrons m * = 0,23-0,34 m0 de -Ga2 O3 [33,34,35,36,37].
La figure 5a illustre l'inverse J -V caractéristiques des échantillons. Après implantation d'argon, la tension de claquage passe de 209 à 252 et 451 V et la figure de mérite de Baliga (VBR 2 /Ron ) pour trois échantillons sont d'environ 25,7, 30,2 et 61,6 MW cm −2 , respectivement. Lors de l'implantation, certains défauts peuvent être introduits et conduire à l'augmentation significative et indésirable du courant de fuite, qui a également été rapportée dans les dispositifs à diodes SiC et GaN Schottky [18,19,20]. Bien que le recuit thermique ait été effectué après l'implantation d'argon, il existe encore des courants de fuite légèrement plus importants pour les échantillons B et C. Par conséquent, les détails de l'étude de la température et de la durée post-recuit sur les caractéristiques électriques directes et inverses doivent être traités dans l'article suivant.

un Le J inversé -V caractéristiques du -Ga2 O3 échantillons à température ambiante. b et c Distribution des tensions de claquage de β-Ga2 O3 SBD avec et sans implantation d'argon
La figure 5b, c présente la distribution des tensions de claquage de β-Ga2 O3 Redresseurs Schottky avec et sans implantation d'argon. Les tensions de claquage parallèles planes idéales de ces dispositifs sont déterminées comme 553 ~ 598 V, en utilisant le champ électrique critique de 5,1 ~ 5,3 MV/cm [11, 39]. La tension de claquage sans implantation d'argon est d'environ 110 ~ 310 V, ce qui correspond à environ 50 % des valeurs idéales. Cependant, avec une dose d'implantation d'argon de 5 × 10 14 cm −2 , la tension de claquage augmente jusqu'à 150~350 V, pas beaucoup plus que l'appareil de référence, alors qu'avec la dose de 1 × 10 16 cm −2 , la tension de claquage se rapproche des valeurs idéales. Dans ce travail, la tension de claquage maximale de 550 V peut être obtenue. De plus, la distribution du champ électrique à la tension de claquage a été simulée. Pour simplifier, un seul niveau d'accepteur midgap a été ajouté avec la profondeur d'implantation de 50 nm déterminée par la simulation TRIM et le modèle d'ionisation incomplet a également été pris en compte [38], comme le montre la figure 6. De toute évidence, la couche à haute résistivité lisse efficacement sur le champ électrique aux coins de jonction et améliore considérablement la tension de claquage par rapport à l'échantillon de référence. Les champs électriques maximum à la tension de claquage sont tous d'environ 5,05 MV/cm, similaire aux résultats rapportés [11, 39], tandis que la position change du coin de l'anode à l'interface au coin de chevauchement juste sous la région d'implantation, comme indiqué dans Fig. 6d, e.
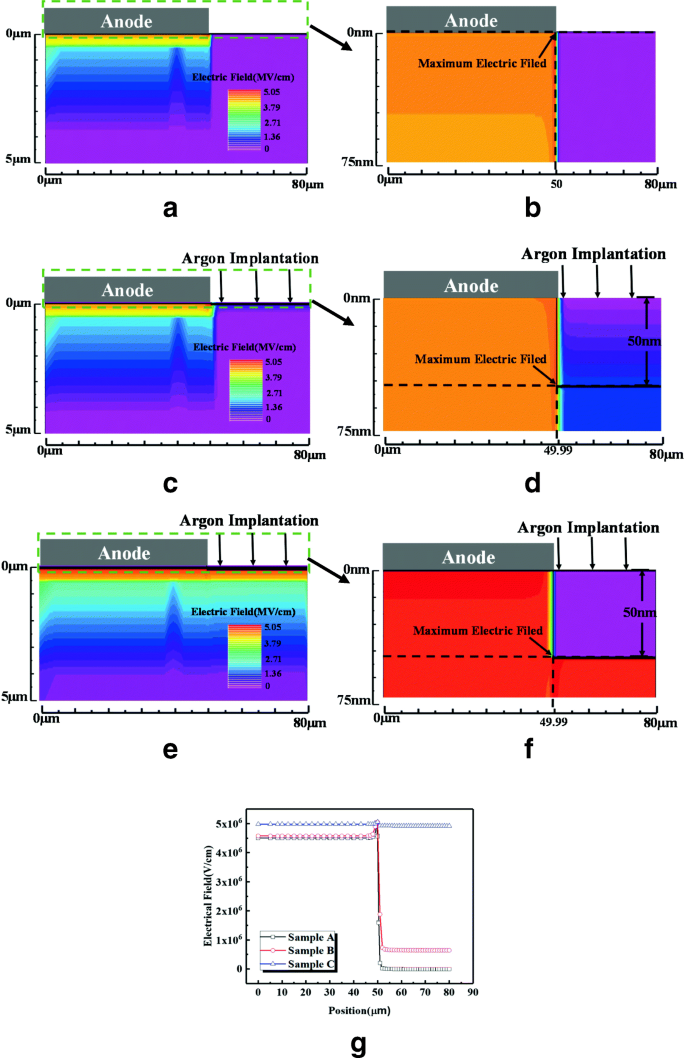
Simulation de la distribution du champ électrique à la tension de claquage des échantillons A-C (a , c , e ), l'image agrandie des régions sélectionnées dans la boîte en pointillés (b , d , f , g ), le champ électrique simulé par rapport à la position le long de la ligne pointillée dans (b , d , f ) pour trois échantillons, Au/Ni/β-Ga2 O3 interface pour l'échantillon A, 50 nm en dessous de l'interface pour les échantillons B et C, respectivement. Le champ maximum est de 5,05 MV/cm
Conclusions
Vertical Au/Ni/β-Ga2 O3 Des diodes à barrière Schottky avec terminaison de bord formées par implantation d'argon ont été fabriquées sur β-Ga2 O3 couche de dérive exfoliée mécaniquement à partir de β-Ga2 de haute qualité orienté (100) O3 substrat en vrac. Par rapport au dispositif de commande, les résistances passantes spécifiques (R sur ) passe de 1,7 à 2,1 et 3,3 mΩ cm 2 et la tension de claquage passe de 209 à 252 et 451 V pour une dose d'implantation de 5 × 10 14 cm −2 et 1 × 10 16 cm −2 , respectivement, avec un courant de fuite inverse plus important. Le champ électrique maximal à la tension de claquage est d'environ 5,05 MV/cm, bien plus grand que celui du SiC et du GaN.
Abréviations
- AFM :
-
Microscope à force atomique
- EFG :
-
Croissance alimentée par film définie par les bords
- FWHM :
-
La pleine largeur à mi-hauteur
- FZ :
-
Zone flottante
- HRXRD :
-
Diffraction des rayons X haute résolution
- JTE :
-
Extension de terminaison de jonction
- MOSFET :
-
Transistor à effet de champ métal-oxyde-semiconducteur
- RMS :
-
Racine moyenne quadratique
- SBD :
-
Diode barrière Schottky
- TE :
-
Émission thermoionique
Nanomatériaux
- ST pilote l'IA vers les périphériques embarqués de périphérie et de nœud avec la boîte à outils de développement de réseau neuronal STM32
- ept :connecteur de carte de bord CMS haute vitesse avec pas de 0,8 mm
- Future Electronics :microphone MEMS de CUI avec une qualité audio améliorée
- Advantech fait passer le calcul accéléré du Cloud à la périphérie avec NVIDIA
- ADLINK :déployez l'IA de la périphérie vers le cloud avec Edge AI Solutions et la plate-forme NVIDIA EGX
- ADLINK lance une logistique plus rapide et plus précise avec Edge IoT Smart Pallet Experience
- Cisco rapproche l'entreprise et l'industrie avec de nouveaux routeurs
- Mise à niveau d'Industrie 4.0 avec l'analyse de périphérie
- Avancer l'Edge Computing, IIC se joint à OpenFog



