Performances de récupération des diodes barrières Schottky GaN verticales dopées au Ge
Résumé
Des diodes à barrière GaN Schottky (SBD) verticales ont été fabriquées sur des substrats GaN autonomes dopés au Ge. La qualité cristalline des SBD a été caractérisée par une mesure de luminescence cathodique, et la densité de dislocation a été déterminée à ~ 1,3 × 10 6 cm − 2 . Avec les mesures de performances électriques effectuées, les SBD montrent une faible tension d'allumage V sur (0,70~0,78 V) et courant élevé I sur /Je désactivé rapport (9,9 × 10 7 ~1.3 × 10 10 ). Les caractéristiques de récupération inverse ont été étudiées. Le temps de récupération inverse a été obtenu à 15,8, 16,2, 18,1, 21,22 et 24,5 ns pour les SBD de 100, 200, 300, 400 et 500 μm de diamètre, respectivement. Pendant ce temps, le temps de récupération inverse et la charge de récupération inverse montrent tous deux une corrélation positive significative avec la surface de l'électrode.
Introduction
Récemment, un semi-conducteur à large bande interdite, tel que le GaN, avec les avantages inhérents, a attiré une attention considérable de la recherche pour les dispositifs électroniques de nouvelle génération, en particulier dans le domaine des hautes fréquences, des hautes puissances et des hautes performances [1,2,3 ,4,5,6]. Parallèlement, grâce aux développements de l'épitaxie en phase vapeur d'hydrure (HVPE), une faible densité de dislocation (≤ 10 6 cm − 2 ) Les substrats GaN sont maintenant disponibles dans le commerce [7,8,9,10]. Par rapport aux dispositifs latéraux, les dispositifs de type vertical fabriqués avec ces substrats sont considérés comme une structure plus avancée qui permet d'obtenir un courant plus important, un chemin de fuite moindre et une meilleure fiabilité du système [11, 12]. Parmi eux, la diode à barrière Schottky (SBD) à base de GaN est un composant essentiel des dispositifs de commutation. A la différence d'une diode bipolaire, le SBD avec sa nature unipolaire réduit considérablement l'effet de stockage des porteurs minoritaires et offre en conséquence une vitesse de commutation élevée avec une faible perte de récupération inverse. Cependant, peu de groupes ont mené une étude systématique des caractéristiques de récupération inverse pour les SBD GaN verticaux [13,14,15,16,17], dont les études se sont davantage concentrées sur la comparaison du temps de commutation dans différentes structures de dispositifs. Ainsi, il existe toujours un besoin urgent d'une enquête approfondie sur le mécanisme de performance de récupération pour les SBD GaN, en particulier pour les verticaux.
Pendant ce temps, étant donné que la technique de contact ohmique a été continuellement explorée pour améliorer les performances des dispositifs dans de nombreux articles publiés [18], le GaN de type n fortement dopé est un lien clé pour la fabrication de dispositifs au nitrure. Dernièrement, Ge est proposé comme alternative au dopant Si dans GaN, car les deux partagent une caractéristique similaire d'impureté de faible niveau (l'énergie d'activation est respectivement de 20 et 17 meV pour Ge et Si) et la distorsion du réseau provoquée par les atomes de Ge se substituant aux sites Ga seraient plus petits en raison de leurs rayons ioniques plus proches [19, 20]. On pense que le dopage Ge forme une surface plus lisse avec moins de défauts [21, 22]. De plus, avec la distorsion du réseau et la tension du film plus faibles, ce dopage est également prometteur dans les appareils électroniques à haute température qui mettent davantage l'accent sur la stabilité thermique. Bien que le GaN dopé au Ge ait été étudié théoriquement, il est essentiel d'étudier l'impact réel sur le dispositif concerné. Dans cet article, les nouveaux SBD GaN verticaux fabriqués sur un substrat GaN autoportant (FS) dopé au Ge sont proposés. Les SBD GaN verticaux présentent une qualité cristalline et une propriété électronique supérieures. Pendant ce temps, les performances de récupération des SBD verticaux sont systématiquement étudiées. Le temps de récupération inverse et la charge de récupération inverse montrent enfin une corrélation positive significative avec la surface de l'électrode.
Méthodes et expériences
Le schéma des structures de l'appareil pour les SBD fabriqués est affiché sur la figure 1a, qui se compose principalement d'un FS de 390 μm n + -Substrat GaN et un n − de 9 μm -Couche de dérive de GaN. Dans ce travail, la couche de substrat GaN orienté (0001) avec une concentration en Ge de 1 × 10 18 cm − 3 et une densité de luxation de 1 × 10 6 cm − 2 a été cultivé par HVPE. Et la couche épitaxiale non dopée sur ce substrat a été développée par dépôt chimique en phase vapeur métalorganique, avec une vitesse de croissance de ~ 2 μm/h. Pour la fabrication du SBD, des contacts ohmiques Ti/Al/Ni/Au ont été formés sur la surface arrière du substrat GaN. Des électrodes Ni/Au Schottky ont été formées sur la surface avant de la couche épitaxiale avec cinq diamètres différents (100, 200, 300, 400 et 500 μm), comme le montre la figure 1b. Vous trouverez plus d'informations sur le processus de fabrication dans notre rapport précédent [23, 24].
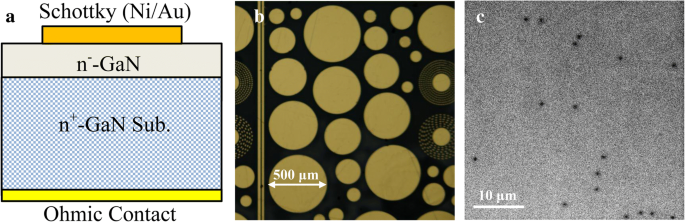
un Coupe transversale schématique du SBD vertical fabriqué. b Image en microscopie optique des différentes électrodes. c Image CL panchromatique de la couche épitaxiale
Les images de cathodoluminescence (CL) ont été obtenues à l'aide d'un microscope électronique à balayage (MEB) Quanta 400 FEG avec une tension d'accélération de 10 kV pour étudier la distribution spatiale de la densité de dislocation pour la couche épitaxiale. Capacité-tension (C-V ) et courant-tension (I-V ) les mesures ont été effectuées à l'aide d'un analyseur de paramètres à semi-conducteurs Keithley 4200 pour évaluer les propriétés électroniques des SBD. Et des mesures dépendantes de la température ont été effectuées dans la plage de 300 à 500 K avec une configuration expérimentale personnalisée.
Résultats et discussion
Le résultat CL de la couche épitaxiale est présenté sur la figure 1c. Comme la luxation est considérée comme un centre de recombinaison non radiative, elle apparaît sur l'image CL sous la forme d'une tache sombre. Puisqu'aucune différence notable de distribution spatiale n'est observée, la valeur moyenne de la densité de dislocation a été calculée comme étant ~ 1,3 × 10 6 cm − 2 , avec les mesures CL effectuées dans plusieurs régions différentes. Ce résultat indique qu'une couche épitaxiale de haute qualité a été obtenue pour les SBD verticaux.
Comme les SBD verticaux ont été caractérisés en mode parallèle, le C-V et G-V les courbes ont été obtenues avec une fréquence de 1 MHz. Les résultats des SBD sont montrés dans les Fig. 2a et b, respectivement, où (1/C 2 ) en fonction de la tension appliquée V est tracé dans l'encart. Ici, concentration de porteurs N d pourrait être évalué avec l'expression :\( {N}_d=\frac{-2}{A^2 q\varepsilon \left[d\left(1/{C}^2\right)/ dV\right]} \), où A est l'aire des électrodes Schottky, q est la charge électronique (1,602 × 10 − 19 C), et ε est la constante diélectrique de GaN (8,854 × 10 − 11 F/m). Par conséquent, le N d de la couche épitaxiale a été déterminé à ~ 6,2 × 10 15 cm − 3 . Et l'angle de phase θ pourrait également être calculé par l'équation suivante :\( \theta ={\tan}^{-1}\left(\frac{2\pi fC}{G}\right) \), où f est la fréquence appliquée, C est la capacité, et G est la conductance mesurée (fuite de grille). Étant donné que les résultats pour différents diamètres sont similaires, l'angle calculé θ par rapport à la tension appliquée V des SBD de 300 μm de diamètre est illustré dans l'encadré de la figure 2b à titre d'exemple. Notez que le θ est très proche de 90°, cela confirme qu'une excellente grille de Schottky avec un faible chemin de fuite est obtenue dans cette étude. Le J-V les caractéristiques sont également présentées dans la Fig. 2c. On voit clairement que le I sur /Je désactivé les ratios sont de 3,8 × 10 9 , 5,9 × 10 8 , 1,3 × 10 10 , 6,5 × 10 8 , et 9,9 × 10 7 pour les SBD de 100, 200, 300, 400 et 500 µm de diamètre, respectivement, dont le I sur et Je désactivé sont définis comme le courant à la tension de grille de 1,6 et - 2 V, respectivement. Après ajustement linéaire, la tension d'activation V sur de SBD verticaux est déterminé à 0,70, 0,76, 0,72, 0,70 et 0,78 V, respectivement, avec des diamètres d'électrode augmentant de 100 à 500 μm. Ces résultats indiquent qu'une bonne propriété électronique a été obtenue pour les SBD verticaux.
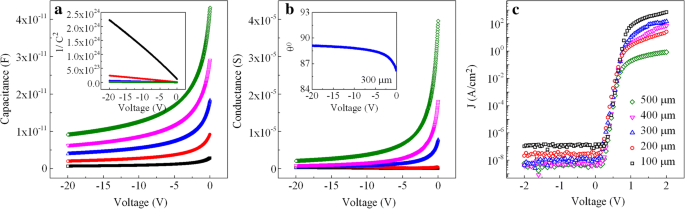
un Température ambiante C-V courbe des SBD verticaux pour chaque électrode différente à une fréquence de 1 MHz. L'encart est un tracé de (1/C 2 ) en fonction de la tension V . b G-V courbe des SBD verticaux pour chaque électrode différente. L'encart est un tracé de l'angle de phase θ par rapport à la tension V pour les SBD de 300 µm de diamètre. c J-V courbe des SBD verticaux pour chaque électrode différente
Un circuit de test typique a été utilisé pour mesurer les caractéristiques de récupération inverse des SBD verticaux, comme le montre la figure 3a. Les signaux de tension d'onde carrée périodiques (de + 20 à - 20 V) ont été appliqués séquentiellement à un dispositif sous test (DUT), où un inducteur parasite stockerait l'énergie magnétique et affecterait le courant. Lorsque le signal de tension a changé, un courant d'oscillation peut avoir lieu pendant la période. Une sonde de courant à grande vitesse avec un oscilloscope Tektronix MDO 4104-3 a été disposée pour détecter la variation de courant transitoire dans les SBD verticaux. Comme la forme d'onde schématique du courant de récupération inverse est illustrée à la Fig. 3b, dans cette étude, t un est défini comme la durée de stockage pendant que t b est défini comme le temps de retard du courant inverse. Et le temps de récupération inverse T rr est défini comme le moment où le courant inverse revient à 10 % du courant inverse maximum de retour I RM , qui est la somme de t un et t b . Et les frais de recouvrement inversés Q rr est obtenu en intégrant le courant inverse jusqu'à T rr qui correspond à la charge accumulée dans une diode.

un Le circuit de test utilisé pour mesurer les caractéristiques de récupération inverse des SBD verticaux. b Forme d'onde schématique des caractéristiques de récupération inverse des SBD verticaux
La figure 4 montre la courbe de récupération inverse des SBD verticaux pour chaque diamètre d'électrode lorsque la tension appliquée est passée de + 20 à − 20 V. Ici, pour les SBD de 100, 200, 300, 400 et 500 μm de diamètre , le T rr les valeurs obtenues étaient de 15,8, 16,2, 18,1, 21,22 et 24,5 ns, tandis que le Q rr les valeurs ont été intégrées à 0,0127, 0,0536, 0,150, 0,280 et 0,405 nC, respectivement. Ces dispositifs verticaux présentaient tous un temps de commutation rapide (inférieur à 25 ns). Un courant inverse considérable est également observé dans les résultats, ce qui pourrait être dû à la plus petite quantité de charge stockée dans les SBD [13]. Pendant ce temps, on voit aussi clairement que la valeur de T rr et Q rr les deux augmentent avec l'élargissement des diamètres des électrodes, et le plus petit montre le T le plus rapide rr de 15,8 ns.
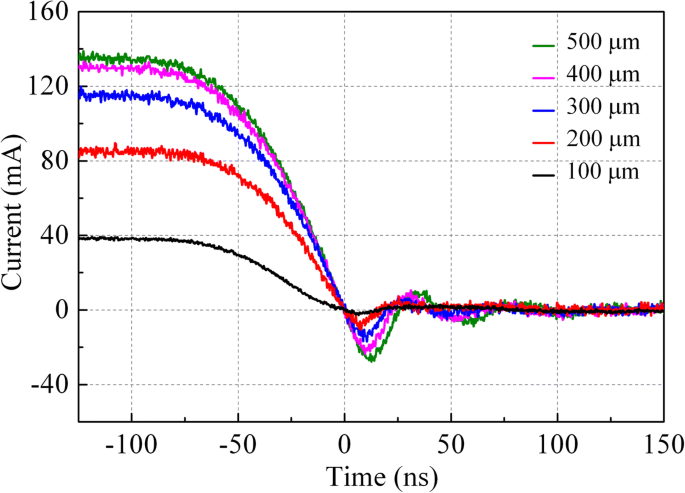
Courant de récupération inverse des SBD verticaux pour chaque électrode différente
Pour étudier plus en détail le mécanisme sous-jacent à ces changements, les SBD verticaux ont également été mesurés lorsque la tension est passée de + 10 à − 10 V. En tant que temps de récupération inverse T rr par rapport au diamètre de la diode d est tracée sur la figure 5, la valeur de T rr pour chaque diode n'a pas été sensiblement modifié. Les frais de recouvrement inversés Q rr contre le d est affiché dans la Fig. 6 simultanément, où les données de deux courbes pointent vers la même tendance. Pendant ce temps, il est à noter que le Q rr des deux tests montrent une corrélation positive significative avec le d 2 , c'est-à-dire la surface de l'électrode.
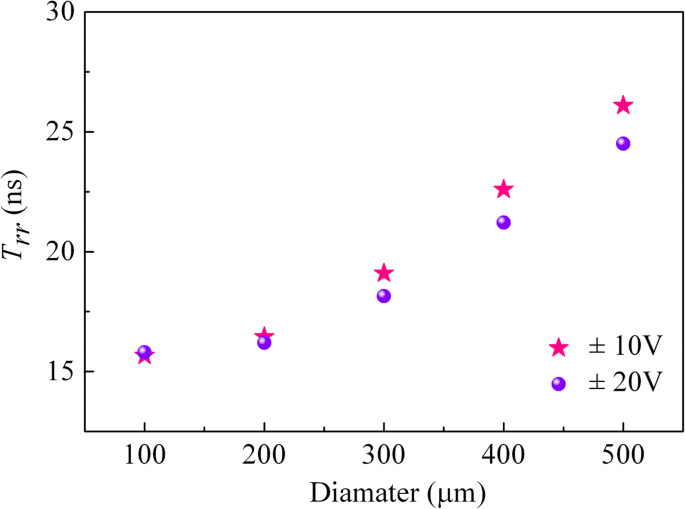
Temps de récupération inversé T rr par rapport au diamètre de l'électrode d
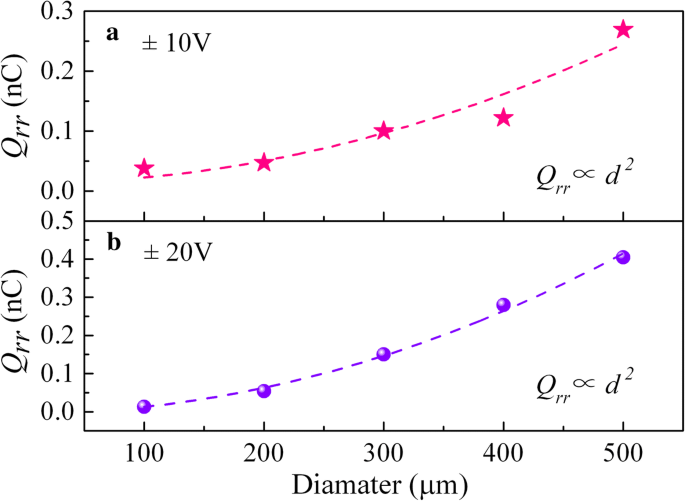
Frais de recouvrement inversés Q rr par rapport au diamètre de l'électrode d
En fait, il est rapporté que l'effet de récupération inverse devrait provenir principalement de l'inductance parasite et du piégeage d'interface des SBD [25, 26]. Considérant que la contribution de l'inductance parasite est caractérisée sous la forme d'un courant d'oscillation qui n'est évidemment pas observé dans ces courbes de récupération inverse, ainsi, le changement du temps de récupération inverse et de la charge de récupération inverse aurait dû résulter des pièges [27, 28]. Étant donné que la concentration des pièges est uniforme dans les SBD verticaux, le Q rr dépendrait de la surface de contact de l'appareil et augmenterait finalement avec la surface de l'électrode, comme le montre la figure 6. Ainsi, les pièges agissent comme un arrêt de champ électrique dans l'interface. Pendant le t un période, le retard a été fortement influencé par le piégeage des porteurs dans la jonction Schottky, tandis que dans le t b période, la vitesse de récupération inverse est également ralentie par le temps nécessaire pour balayer la charge stockée hors de la jonction. Ces résultats sont cohérents avec notre rapport précédent [29], qui suggérait le RC la constante de temps augmente avec l'augmentation du diamètre de l'appareil et montre une bonne dépendance avec le temps de récupération inverse. Et une amélioration supplémentaire des caractéristiques de récupération inverse pourrait être attendue d'une électrode plus petite ou d'une couche de dérive plus mince dans ces dispositifs.
De plus, les performances de récupération des SBD verticaux sont davantage étudiées à une température plus élevée. La figure 7 montre le courant de récupération inverse pour les SBD GaN de 500 μm de diamètre qui ont été mesurés à 300, 400 et 500 K, respectivement. Ni le temps de récupération inverse ni la charge de récupération inverse ne sont observés modifiés avec l'augmentation de la température. Ces résultats sont cohérents avec l'analyse ci-dessus, car la concentration de piège n'est pas très sensible à la température. Inversement, il est rapporté que le temps de récupération inverse des SBD à base de Si augmenterait de 191 % lorsque la température passerait de 300 à 425 K [17]. Ici, avec une durée de vie de porteuse courte et une bande interdite plus large, les SBD GaN offrent des améliorations substantielles de la capacité de gestion du courant, de la récupération inverse et de la perte d'énergie. Comme la stabilité thermique des SBD à base de GaN est supérieure à celle des semi-conducteurs traditionnels à bande interdite étroite [30], on peut en conclure que le GaN est également un matériau approprié pour les dispositifs de commutation appliqués à un environnement à haute température.
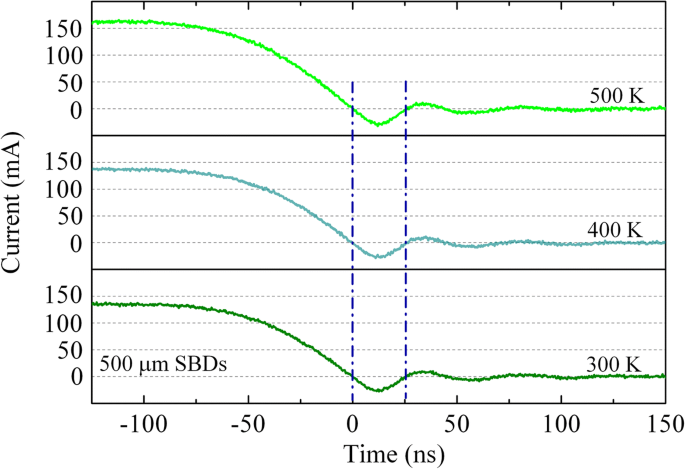
Caractéristiques de récupération inversée pour les SBD de 500 μm de diamètre mesurés à 300, 400 et 500 K, respectivement
Conclusions
En résumé, nous avons fabriqué des SBD GaN verticaux sur des substrats GaN FS dopés au Ge cultivés par HVPE. Avec la caractérisation des matériaux et les mesures courant-tension effectuées, cela indique qu'une excellente qualité de cristal et une excellente propriété électronique ont été obtenues pour les SBD verticaux. Les caractéristiques de récupération inverse ont été systématiquement étudiées. Le temps de récupération inverse obtenu était de 15,8, 16,2, 18,1, 21,22 et 24,5 ns pour les diodes de 100, 200, 300, 400 et 500 μm de diamètre, respectivement. Pendant ce temps, le temps de récupération inverse et la charge de récupération inverse montrent tous deux une corrélation positive significative avec la surface de l'électrode. Nos résultats peuvent servir de référence pour améliorer encore les performances de récupération des SBD à base de GaN.
Abréviations
- CL :
-
Cathodoluminescence
- C-V :
-
Capacité-tension
- DUT :
-
Appareil en cours de test
- FS :
-
Autonome
- GaN :
-
Nitrure de gallium
- HVPE :
-
Epitaxie en phase vapeur d'hydrure
- I-V :
-
Courant-tension
- SMD :
-
Diodes à barrière Schottky
- SEM :
-
Microscope électronique à balayage
Nanomatériaux
- Diodes
- Périphériques quantiques
- diodes spéciales
- Navistar :performances à toute épreuve
- Technologie HDPE haute barrière contre l'humidité pour les emballages flexibles multicouches
- Effet de l'irradiation ultraviolette sur les caractéristiques des diodes 4H-SiC PiN
- Étude sur la polarisation de surface de l'hétérostructure GaN/AlGaN/GaN coiffée d'Al2O3 par spectroscopie photoélectronique à rayons X à résolution angulaire
- Cibler les cellules endothéliales avec des nanoparticules GaN/Fe multifonctionnelles
- 3 façons d'améliorer les performances de votre pompe verticale



