Présentation de la diode barrière Schottky à base de semi-conducteur Ga2O3 à bande interdite ultra-large pour les applications d'électronique de puissance
Résumé
Oxyde de gallium (Ga2 O3 ) est un nouveau matériau semi-conducteur qui présente l'avantage d'une bande interdite ultra-large, d'un champ électrique de claquage élevé et d'une grande figure de mérite de Baliga (BFOM). ). Dans cet article, les propriétés physiques de base de Ga2 O3 semi-conducteur ont été analysés. Et les récentes enquêtes sur le Ga2 O3 SBD ont été examinés. Pendant ce temps, diverses méthodes pour améliorer les performances, y compris la tension de claquage et la résistance à l'état passant, ont été résumées et comparées. Enfin, la perspective de Ga2 O3 SBD pour les applications d'électronique de puissance a été analysé.
Contexte
Avec le développement rapide des industries de l'énergie électrique, du contrôle industriel, de l'électronique automobile et de l'électronique grand public, il existe une énorme demande de dispositifs à semi-conducteurs de puissance haute performance. Les matériaux semi-conducteurs à large et ultralarge bande interdite peuvent satisfaire cette demande [1, 2]. Parmi les cinq structures de Ga2 O3 monocristal, monoclinique β -Ga2 O3 est le plus stable, et il a une bande interdite ultra-large (E g ~ 4,8 eV) et un champ électrique de claquage très élevé (E br ~ 8 MV cm −1 ), par rapport au Si traditionnel et au SiC et GaN développés plus tard. En conséquence, β -Ga2 O3 montre une figure de mérite de Baliga bien élevée (BFOM =\( \varepsilon \mu {E}_{\mathrm{b}}^3 \); ε est la constante diélectrique relative, et μ est la mobilité électronique). Le BFOM est un critère important pour évaluer la pertinence d'un matériau pour l'application d'appareils électriques [3,4,5,6,7,8,9,10,11]. Le tableau 1 compare les propriétés physiques de base du Si, la bande interdite large (GaN, SiC) et la bande interdite ultralarge (β -Ga2 O3 ) matériau semi-conducteur. De plus, pour la croissance du monocristal β -Ga2 O3 substrat, il existe des méthodes de croissance en fusion faciles, peu coûteuses et réalisables en masse à pression atmosphérique, telles que la zone flottante (FZ) [12, 13] et la croissance alimentée par film (EFG) à bord défini [14,15 ,16,17]. C'est une autre supériorité de Ga2 O3 sous l'aspect d'une croissance monocristalline de haute qualité, par rapport au SiC et au GaN. Par conséquent, β -Ga2 O3 est un candidat prometteur pour les dispositifs semi-conducteurs haute puissance de nouvelle génération tels que la diode à barrière Schottky (SBD) [18,19,20,21,22,23,24] et le transistor à effet de champ métal-oxyde-semiconducteur (MOSFET) [ 25,26,27,28,29]. Il est à noter que de nombreuses études sur le Ga2 O3 la croissance des matériaux et la fabrication et la caractérisation de dispositifs d'alimentation ont été réalisées au cours des dernières années. Dans cet article, nous avons donc examiné les propriétés des matériaux de la bande interdite ultralarge Ga2 O3 semi-conducteur et les investigations du Ga2 O3 SBD pour les applications d'électronique de puissance. En SBD, les paramètres de performance les plus importants sont la tension de claquage (V br ) et sur résistance (R sur ), donc en résumant et en comparant les différentes méthodes d'amélioration du V br et R sur performances, nous souhaitons que notre travail de relecture soit bénéfique pour le développement de Ga2 O3 -appareils d'alimentation basés.
Propriétés physiques du semi-conducteur à l'oxyde de gallium
Oxyde de gallium (Ga2 O3 ) est un nouveau matériau semi-conducteur d'oxyde, mais il a une longue histoire de recherche. L'enquête sur les équilibres de phases dans l'Al2 O3 -Ga2 O3 -H2 Le système O remonte à 1952, et R. Roy et al. déterminé l'existence de polymorphes de Ga2 O3 et leurs relations de stabilité [30]. En 1965, H.H. Tippins et al. a étudié l'absorption optique et la photoconductivité dans le bord de bande de β -Ga2 O3 et a confirmé sa bande interdite avec une valeur de 4,7 eV [6]. Dans les années 1990, un certain nombre de méthodes sur la croissance en fusion de Ga2 O3 croissance massive monocristalline et épitaxiale de Ga2 O3 le film avait été développé. Au cours des 5 dernières années, en raison de ses propriétés spéciales et de la croissance réussie d'un substrat monocristallin de haute qualité et de grande taille, Ga2 O3 matériel a suscité beaucoup d'intérêt pour la recherche.
Jusqu'à présent, les gens ont trouvé cinq phases cristallines de Ga2 O3 , c'est-à-dire α , β , γ , δ , et ε phases. Les relations de transformation entre ces cinq phases sont illustrées à la figure 1 [30]. La phase monoclinique β- Ga2 O3 a la meilleure stabilité thermique, tandis que les quatre autres phases sont métastables et sont susceptibles de se transformer en β- Ga2 O3 à hautes températures. Par conséquent, à l'heure actuelle, la plupart des études se concentrent sur β- Ga2 O3 . Certaines enquêtes récentes ont également révélé que d'autres phases présentaient des propriétés matérielles spéciales qui β phase n'a pas eu. Par exemple, α- Ga2 O3 a une structure cristalline de corindon similaire à celle du saphir (Al2 O3 ), il est donc relativement facile de faire croître par épitaxie des α- de haute qualité Ga2 O3 film monocristallin sur l'Al2 existant actuellement O3 substrat monocristallin. Phase hexagonale ε- Ga2 O3 est la deuxième phase stable et présente un fort effet de polarisation spontanée qui est bénéfique pour former un gaz d'électrons 2D à haute densité dans l'interface d'hétérojonction [31], similaire à la condition dans la jonction AlGaN/GaN. Ces dernières années, en raison de la croissance réussie des β- de grande taille Ga2 O3 substrat monocristallin et sa meilleure stabilité, jusqu'à présent, les études sur β- Ga2 O3 sont bien plus que ceux des quatre autres phases. Ainsi, dans cet article, nous passons principalement en revue les travaux de recherche sur β- Ga2 O3 .
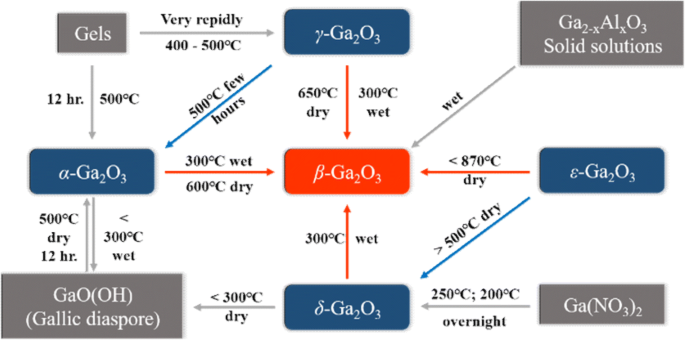
Relations de transformation entre les phases cristallines de Ga2O3 et leurs hydrates [30]
β- Ga2 O3 appartient au système monoclinique et est thermiquement stable. Ses constantes de réseau sont a = 1.22 nm, b = 0,30 nm, et c = 0,58 nm, comme le montre la Fig. 2. La structure cristalline de β- Ga2 O3 détermine qu'il a une certaine conductivité, mais qui est limitée par sa bande interdite ultralarge (4,7 à 4,9 eV), la plus large de tous les matériaux semi-conducteurs transparents connus. Ce n'est que s'il existe des niveaux d'énergie de défaut dans la bande interdite et que des électrons libres sont générés que le matériau a une conductivité relativement forte. Pour la plupart des semi-conducteurs à large bande interdite, la conductivité se forme simplement à cause de l'existence de niveaux de défauts dans la bande interdite, tels que le semi-conducteur ZnO [32]. La conduction électrique intrinsèque de β- Ga2 O3 provient des électrons libres conduits par les défauts ponctuels formés dans la masse du cristal. La plupart des études ont démontré que les lacunes en oxygène sont les principaux défauts de la conduction électrique [33,34,35].

La structure réticulaire de β-Ga2 O3 cristal. Réimprimé de la réf. [5]
Il est intéressant de noter qu'en raison de l'existence de nombreuses lacunes d'oxygène dans les β- polycristallins Ga2 O3 , il est facile d'absorber une sorte de gaz pour faire changer la résistivité, il y a donc eu de nombreux rapports sur l'utilisation de β- Ga2 O3 fabriquer des capteurs de gaz pour la détection de H2 , CH4 , CO et O2 [36,37,38,39]. De plus, parce que la constante de réseau de β- Ga2 O3 dans la direction [100] est beaucoup plus large que celles dans les directions [001] et [010], il est facile de décoller un film ultrafin le long de la direction [100] pour la fabrication du dispositif [27, 40, 41, 42, 43]. En même temps, en raison de cette caractéristique de structure cristalline, dans la fabrication de β- Ga2 O3 plaquettes, la coupe de la masse dans la direction [100] peut acquérir une surface plane avec une très faible rugosité.
Par rapport au SiC et au GaN, β- Ga2 O3 possède des caractéristiques électriques particulières, parmi lesquelles la bande interdite ultralarge (4,7 à 4,9 eV) est la plus importante. Cela lui confère un champ électrique de claquage critique très élevé (E br ≈8 MV/cm), environ le double de ceux du SiC et du GaN. Le champ électrique de claquage du matériau est un paramètre très important pour les dispositifs de puissance unipolaires. Si un matériau a un E plus élevé br , dans le matériau d'épaisseur unitaire, un champ électrique plus élevé peut être maintenu, ce qui est avantageux pour la réduction de la taille du dispositif et l'amélioration du niveau d'intégration des modules de puissance. La figure 3 montre les limites fondamentales de la résistance à l'état passant (R sur ) en fonction de la tension de claquage (V br ) pour plusieurs semi-conducteurs importants dont Si, GaAs, SiC, GaN, Ga2 O3 , et le diamant [5]. A partir de cette figure, nous pouvons constater que la perte de conduction de Ga2 O3 dispositifs est un ordre de grandeur inférieur à ceux des dispositifs SiC et GaN au même V br . Ainsi, Ga2 O3 montre son grand potentiel dans les dispositifs unipolaires. Comme la mobilité électronique à saturation de β- Ga2 O3 est relativement faible (~ 200 cm 2 V − 1 s − 1 ), β- Ga2 O3 n'est pas adapté aux appareils haute fréquence par rapport au GaN. Cependant, sa large bande interdite peut compenser cet inconvénient car une couche de dérive plus mince a une largeur d'appauvrissement plus petite; ainsi, la capacité parasite peut être diminuée pour répondre aux exigences des applications haute fréquence. De plus, la bande interdite d'environ 4,8 eV rend Ga2 O3 possèdent une bande d'onde d'absorption spéciale (250-280 nm) qui se situe juste dans la gamme des rayons ultraviolets (UV) aveugles solaires, donc Ga2 O3 est un bon matériau naturel pour la fabrication de détecteurs UV [44,45,46,47].
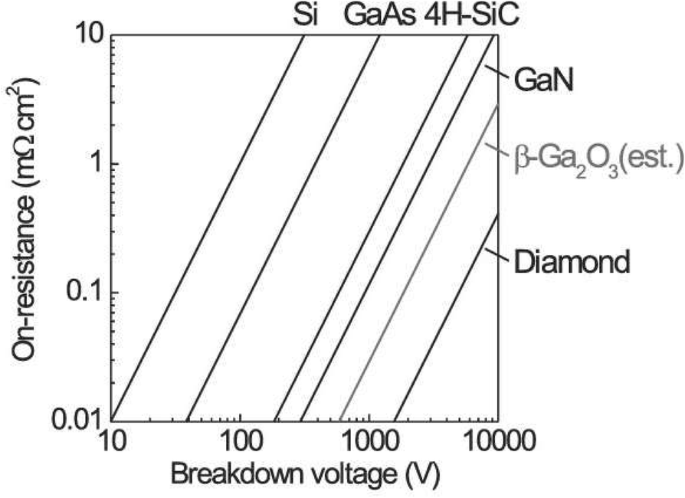
Limites théoriques de la résistance à l'état passant (R sur ) en fonction de la tension de claquage (V br ) pour β-Ga2 O3 et semi-conducteurs représentatifs. Réimprimé de la réf. [26]
Ces dernières années, le dopage de type n de β- Ga2 O3 a été essentiellement réalisé. Les éléments Si et Sn, en tant qu'impuretés donneuses à faible niveau d'énergie, ont une énergie d'activation faible. La concentration de dopage peut être bien modulée pour être de l'ordre de 10 15 –10 19 cm −3 [47], avec la valeur la plus élevée de 10 20 cm −3 parvenu. Dans le même temps, avec le changement de concentration de dopage, les propriétés optiques et électriques changeront également. Par exemple, la résistivité de type n β- Ga2 O3 changements de l'ordre de 10 −3 − 10 12 Ω cm avec l'évolution de la concentration de dopage [48, 49]. La bande interdite change également avec différentes concentrations de dopage, de sorte que les caractéristiques d'absorption de la lumière de Ga2 O3 sont influencés [50].
Du développement de Ga2 O3 , ce matériau présente encore certains inconvénients comme suit. (1) Le dopage de type P est un grand défi du Ga2 O3 Matériel. Parce que les niveaux d'accepteurs sont loin de la bande de valence de β- Ga2 O3 , l'énergie d'activation des impuretés acceptrices est très élevée. Pendant ce temps, les impuretés de fond de type n dans Ga2 O3 le cristal produira également un effet d'auto-compensation sur les impuretés acceptrices, entraînant l'auto-isolation du matériau. Par conséquent, il n'y a toujours pas eu d'action efficace de type p. (2) La conductivité thermique de Ga2 O3 est trop bas. Des investigations expérimentales et théoriques ont prouvé que la conductivité thermique de β- Ga2 O3 n'est que de 0,1-0,3 W cm −1 K −1 [51,52,53]. Ceci est défavorable au dispositif d'alimentation utilisé dans des circonstances de haute tension et de courant élevé. Une accumulation excessive de chaleur affectera sérieusement les performances et la fiabilité de l'appareil. (3) La mobilité des transporteurs est faible. La mobilité théorique de Ga2 O3 est limité à environ 200 cm 2 /V s en raison de l'influence de la diffusion [54]. Une faible mobilité a un impact négatif sur la fréquence et les caractéristiques de courant.
Le concept de base de la diode barrière Schottky
Le contact Schottky, le contact ohmique et la distribution du champ électrique sont les facteurs clés du SBD pour atteindre des performances élevées, y compris la résistance à l'état passant (R sur ) et la tension de claquage (V br ), de sorte que diverses méthodes pour les améliorer sont particulièrement importantes.
Selon le concept de barrière Schottky, la hauteur de la barrière est liée au travail de sortie du métal Schottky et à l'affinité électronique du semi-conducteur. Le travail d'extraction de différents métaux change périodiquement, et le métal doit avoir un travail d'extraction plus important que le semi-conducteur pour former la barrière de Schottky. Le nickel (Ni) et le platine (Pt) sont les métaux Schottky communs pour β- Ga2 O3 , et leurs hauteurs de barrière sont dérivées avec diverses méthodes [55,56,57,58,59,60,61,62,63,64,65,66,67,68,69,70,71,72,73,74 ,75,76,77]. La région d'appauvrissement sous la surface du semi-conducteur a besoin de l'épaisseur nécessaire pour empêcher l'effet tunnel du porteur, et cela nécessite la concentration de dopage limitée du semi-conducteur. Les valeurs courantes de concentration de dopage sont 10 16 –10 17 cm −3 dans le β- Ga2 O3 substrat ou couche d'épitaxie [56,57,58,59,60,61,62]. La hauteur de la barrière est en fait affectée par les états de l'interface et s'écarte d'une simple relation avec la fonction de travail. Le prétraitement de surface vise à réduire les états d'interface, y compris les lacunes d'oxygène près de la surface et les liaisons pendantes [78].
Le contact ohmique est le lien de base entre le métal et le semi-conducteur. Une faible résistance spécifique du contact ohmique est utile pour que les appareils diminuent la résistance de contact (R s ) et sur résistance (R sur ). Les méthodes traditionnelles pour obtenir une faible résistance de contact sont le choix d'un métal à faible travail et d'un dopage important. En fait, le travail de sortie du métal de contact est toujours sans influence pour la formation de contact ohmique en raison de l'épinglage des états d'interface. Le dopage important du semi-conducteur devient la technique principale pour le contact ohmique. Les principaux objectifs sont l'amélioration de la concentration des porteurs et l'abaissement de la barrière d'interface. Le RTA (recuit thermique rapide) améliore les caractéristiques interfaciales et réduit la résistance de contact. Y. Yao et al. testé neuf métaux en tant que métaux de contact ohmiques au β- Ga2 O3 et ont trouvé que le titane (Ti) et l'indium (In) présentent un bon comportement ohmique dans des conditions spécifiques [79]. Après recuit à haute température, seul le titane peut conserver la morphologie continue. De manière similaire, la plupart des études ont appliqué le titane comme métal de contact ohmique avec β- Ga2 O3 et obtenu des performances favorables de l'appareil [60,61,62,63,64,65,66,67,68,69,70].
Le comportement de claquage est lié à la distribution du champ électrique à l'intérieur des dispositifs, et la jonction cylindrique et la jonction sphérique ont un champ électrique plus grand que la jonction plan parallèle dans la même condition [1]. Par conséquent, certaines méthodes de protection de terminaison de bord sont nécessaires, telles qu'une plaque de champ pour améliorer la tension de claquage [19, 23, 68]. Les états d'interface appelés charges d'interface ont normalement un impact sur le champ électrique à proximité de la surface du semi-conducteur et provoquent un claquage prématuré. Le courant de fuite est l'indicateur du comportement de claquage et est généralement affecté par les défauts internes du semi-conducteur, y compris les dislocations. Les deux situations provoquent l'instabilité des appareils et peuvent diminuer la tension de claquage qui doit être évitée. La pratique courante pour réduire l'impact des états d'interface est la passivation de surface, et un substrat de haute qualité est également requis pour augmenter la tension de claquage.
Diode barrière Schottky basée sur β- Ga2 O3
Les difficultés de croissance de substrats monocristallins de haute qualité et à faible coût ont affecté la commercialisation des dispositifs SiC et GaN. Tandis que Ga2 O3 les substrats monocristallins peuvent être cultivés par une méthode de fusion à faible coût, les dispositifs d'alimentation basés sur Ga2 O3 monocristal ont attiré beaucoup d'attention ces dernières années. À l'heure actuelle, la technologie de dopage de type n du Ga2 O3 est assez mature, mais le manque de dopage de type p rend Ga2 O3 ne peut pas être appliqué dans les appareils bipolaires. La bande interdite ultra large en fait un gros avantage dans l'application de dispositifs unipolaires. Par conséquent, le développement du Ga2 O3 Les dispositifs de puissance sont dominés par deux types de dispositifs unipolaires, à savoir la diode à barrière Schottky (SBD) et le transistor à effet de champ métal-oxyde-semiconducteur (MOSFET) [23, 55, 56].
Avec le développement de la technologie des matériaux semi-conducteurs à large bande interdite (WBG), le dispositif SBD basé sur le semi-conducteur WBG commence à remplacer la diode à jonction p-n pour s'appliquer au système électronique de puissance car aucun effet de stockage de porteur minoritaire n'existe dans le SBD et sa perte de commutation est assez faible. En théorie, comparé au SiC et GaN SBD, Ga2 O3 Le SBD peut atteindre la même tension de claquage avec une couche de dérive beaucoup plus fine. Dans le même temps, une couche de dérive plus mince réduit la capacité parasite, raccourcissant le temps de récupération inverse du dispositif. Les principaux progrès du développement de Ga2 O3 Le SBD est illustré à la figure 4. Avec le développement de la technologie d'épitaxie, la structure SBD est passée de la structure simple à base de substrat initiale à la structure complexe à base de substrat et de film épitaxié. Par la suite, grâce à l'exploration progressive des processus de fabrication de l'appareil, des structures terminales avancées, notamment une plaque déposée et une tranchée, sont apparues, améliorant encore les performances de l'appareil. Ga2 O3 SBD commence à présenter son potentiel dans les applications d'électronique de puissance.
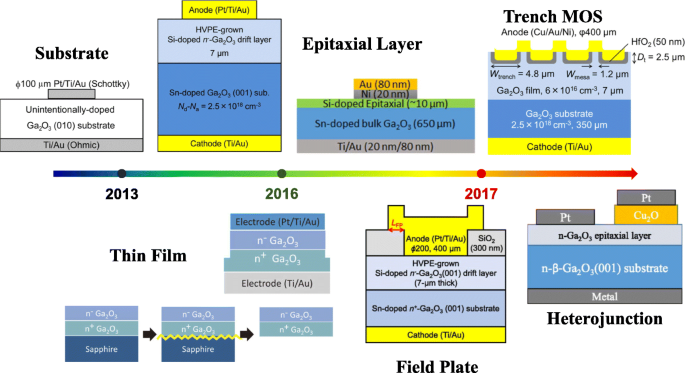
Le développement de Ga2 O3 SBD ces dernières années [16, 18, 62, 68-71]
En tant que nouveau matériau semi-conducteur à large bande interdite, les gens ont été confrontés à de nombreux problèmes de base lors de la phase initiale de développement du Ga2 O3 , donc la progression du développement de Ga2 O3 SBD reflète très bien l'évolution de la puissance SBD. La partie la plus importante dans SBD est la jonction Schottky, donc dans les premiers travaux de recherche sur Ga2 O3 SBD, il en existe un nombre important se concentrant sur l'étude de la jonction Schottky, incluant principalement le contact entre Ga2 O3 et différentes électrodes Schottky (Ni、Cu、Au、Pt、TiN) [57,58,59], le mécanisme de transport d'électrons de la jonction Schottky, les problèmes d'états d'interface, l'inhomogénéité de barrière et la force d'image existant dans le contact Schottky, et les méthodes d'acquisition d'un contact ohmique parfait dans l'interface cathodique [60, 61].
Avec la perspicacité progressive des propriétés physiques et l'amélioration croissante des procédés de fabrication, les performances des dispositifs sont progressivement améliorées. Voici quelques travaux typiques dans le développement de Ga2 O3 SBD.
En 2013, K. Sasaki et al. dans Tamura Corporation fabriqué SBD basé sur de haute qualité (010) β –Ga2 O3 substrat monocristallin développé par la méthode des zones flottantes [62]. Ils ont étudié l'impact des différentes concentrations de dopage dans le substrat sur les performances du dispositif et ont découvert qu'une concentration de dopage plus élevée induisait une résistance à l'état passant plus faible, mais une tension de claquage inverse plus faible et un courant de fuite inverse plus important. La figure 5 montre les caractéristiques de claquage inverse des deux SBD fabriqués avec (010) β –Ga2 O3 substrats avec différentes concentrations de dopage. La tension de claquage atteint 150 V. Le facteur d'idéalité des deux appareils est proche de 1. Et la hauteur de barrière Schottky du Pt/β –Ga2 O3 l'interface a été estimée entre 1,3 et 1,5 eV.
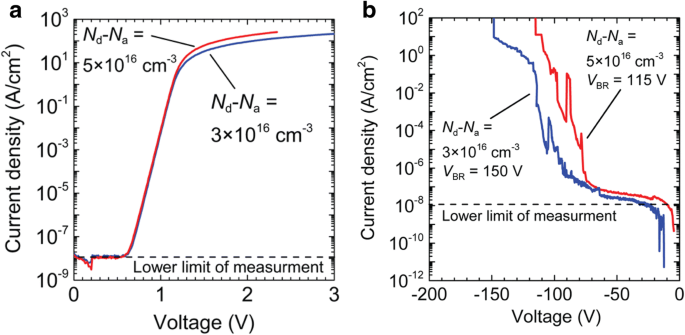
un , b Caractéristiques électriques avant et arrière du SBD basées sur (010) β -Ga2 O3 substrats avec différentes concentrations de dopage. La limite inférieure de la mesure de la densité de courant est de 10 -8 A/cm 2 . Réimprimé de la réf. [62]
Des chercheurs de l'Institut de microélectronique de l'Académie chinoise des sciences (IMECAS) et de l'Université du Shandong ont collaboré pour étudier le SBD sur la base de β orienté (100) –Ga2 O3 substrat en vrac. En 2017, ils ont signalé un Pt/β –Ga2 O3 SBD et ses caractéristiques électriques dépendantes de la température. L'analyse par diffraction des rayons X (XRD) et microscopie électronique à transmission à haute résolution (HRTEM) a montré que le β –Ga2 O3 Le monocristal en vrac développé par la technique de croissance alimentée par film (EFG) défini par les bords présentait une bonne orientation (100) et une bonne qualité cristalline (Figs. 6a, b). Grâce à des mesures I-V et à une modélisation d'émission thermoionique, le Pt/β fabriqué –Ga2 O3 L'appareil SBD a montré de bonnes performances, y compris un rapport de rectification de 10 10 , facteur d'idéalité (n ) de 1.1, hauteur de barrière Schottky (Φ B ) de 1,39 eV, tension de seuil (V bi ) de 1,07 V, résistance à l'état passant (R sur ) de 12,5 mΩ cm 2 , densité de courant directe à 2 V (J @2V ) de 56 A/cm 2 , et une concentration efficace des donneurs (N d − N un ) de 2,3 × 10 14 cm −3 (Fig. 6c, d). De bonnes performances en fonction de la température ont également été trouvées dans l'appareil (Figs. 6e, f). Avec l'augmentation de la température, R sur et J @2V s'est amélioré, démontrant que l'appareil pouvait bien fonctionner à haute température. Dans leurs travaux suivants, ils ont étudié en profondeur la dépendance à la température du facteur d'idéalité et de la hauteur de barrière de Schottky et ont découvert que ce type de caractéristiques de température peut être expliqué par la distribution gaussienne de l'inhomogénéité de la hauteur de barrière [61]. En 2018, ils ont encore optimisé les paramètres de croissance cristalline et amélioré la concentration de dopage en Sn (N d − N un = 2,3 × 10 14 cm −3 ). Le nouveau Pt/β –Ga2 O3 Le dispositif SBD affiche des performances nettement améliorées, y compris la densité de courant directe (J @2V = 421 A/cm 2 ), résistance à l'état ON (R sur = 2,9 mΩ cm 2 ), un temps de récupération inverse court (20 ns) et une tension de claquage inverse supérieure à 200 V [63]. Leurs travaux indiquent qu'EFG a cultivé β –Ga2 O3 le monocristal est une application prometteuse pour les appareils électriques.

un Courbe de diffraction des rayons X (XRD) de (100) β -Ga2 O3 substrat monocristallin, montrant clairement les pics des plans (400), (600) et (800). b Image au microscope électronique à transmission à haute résolution (HRTEM) en coupe transversale de Pt/β -Ga2 O3 Contact Schottky et micrographie à transformée de Fourier rapide (FFT) de β -Ga2 O3 cristal. c Courbe J–V avant et arrière d'un Pt/β -Ga2 O3 SBD et le schéma du SBD (en médaillon). d Courbe J–V directe en tracé linéaire et semi-logarithmique. e Courbes J–V dépendantes de la température et tracé de Richardson (en médaillon). f Dépendance de la résistance ON et de la densité de courant direct sur la température. Réimprimé de la réf. [60]
Q. Feng et al. de l'Université de Xidian ont étudié les processus de préparation du dépôt laser pulsé (PLD) et les propriétés physiques de base du β dopé à l'Al –Ga2 O3 cinéma [64,65,66]. Doping Al est capable de régler la bande interdite de β –Ga2 O3 en incorporant différents rapports d'atomes d'Al. Basé sur ce genre de film dopé à l'Al, Ni/β -(AlGa)2 O3 Le dispositif SBD a été fabriqué et caractérisé. La hauteur de la barrière Schottky est de 1,33 eV. Le rapport marche-arrêt actuel et la résistance marche atteignent 10 11 et 2,1 mΩ cm 2 , respectivement [65]. Ils ont également étudié l'influence de la température sur le facteur d'idéalité et la hauteur de la barrière Schottky et ont également conclu que ces caractéristiques de dépendance à la température de n et Φ B ont été attribuées aux inhomogénéités de la barrière de Schottky en supposant l'existence d'une distribution gaussienne de la hauteur de la barrière [66].
Avec le développement de la technologie d'épitaxie de film, l'épitaxie en phase vapeur aux halogénures (HVPE) a été utilisée pour cultiver Ga2 O3 film. En raison des avantages de la vitesse rapide de l'épitaxie et de la haute qualité du film, Ga2 cultivé en HVPE O3 est très approprié pour fabriquer la couche de dérive du SBD haute tension. En 2015, M. Higashiwaki et al. à l'Institut national des technologies de l'information et des communications (NICT) a augmenté de 7 μm d'épaisseur légèrement dopée (~ 1 × 10 16 cm −3 ) couche épitaxiale sur le (N fortement dopé d − N un = 2,5 × 10 18 cm −3 ) (001) β- Ga2 O3 substrat par la méthode HVPE et en outre un dispositif SBD fabriqué. Les caractéristiques C-V et I-V du dispositif à différentes températures ont été étudiées. La tendance au changement de la hauteur de la barrière Schottky, de la tension de seuil, des courbes C-V et I-V avec la température a été soulignée. La figure 7 montre la structure de l'appareil et les courbes J–V–T avant et arrière [16]. Il a été constaté qu'à 21-200 °C, la hauteur de la barrière restait presque constante. Le courant direct et le courant inverse s'accordaient bien avec les modèles d'émission thermoionique (TE) et d'émission de champ thermoionique (TFE), respectivement. Leurs résultats ont démontré le potentiel de l'application du Ga2 O3 SBD dans les appareils électriques de nouvelle génération.
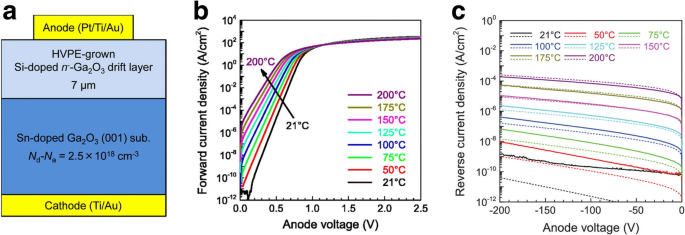
un Structure du dispositif SBD basée sur le n − cultivé en HVPE de 7 μm d'épaisseur - Ga2 O3 couche de dérive homéoépitaxiale sur n + - Ga2 O3 substrat monocristallin. b Caractéristiques J–V directes de l'appareil mesurées entre 21 et 200 °C. c Inverser J–V à 21–200 °C (les lignes pleines et pointillées représentent les résultats expérimentaux et simulés, respectivement). Réimprimé de la réf. [16]
En 2016, M. Oda et al. dans FLOSFIA Inc. a publié un ouvrage sur α -Ga2 O3 SBD [18]. Grâce à une technique de dépôt chimique en phase vapeur (CVD), c'est-à-dire MIST EPITAXY®, ils se sont successivement fortement développés (3-4 μm d'épaisseur) et légèrement dopés α -Ga2 O3 films sur saphir (Al2 O3 ) substrats. Après avoir soulevé le α -Ga2 O3 des couches des substrats, de la cathode et de l'anode ont été déposées sur la surface inférieure et supérieure du n − - Ga2 O3 /n + - Ga2 O3 couches, respectivement (Fig. 8). L'appareil avec un n − d'épaisseur 2580 nm - Ga2 O3 La couche a montré une tension de claquage élevée de 855 V et une résistance à l'état passant de 0,4 mΩ cm 2 . Alors que l'appareil avec un plus fin (430 nm) n − - Ga2 O3 Les couches SBD présentaient une très faible résistance à l'état passant de 0,1 mΩ cm 2 et une tension de claquage de 531 V. En 2018, ils ont en outre signalé ce type de dispositif réalisé avec un boîtier TO220 [67]. Une capacité de jonction de 130 pF a été obtenue, de sorte que l'appareil a montré une meilleure caractéristique de récupération inverse par rapport à SiC SBD et Si SBD. Dans le même temps, après emballage, le dispositif présentait une résistance thermique de 13,9 °C/W, comparable à celle du SiC SBD avec le même emballage (12, °C/W), démontrant que l'adoption d'une couche mince de dérive permet de compenser efficacement la inconvénient de la mauvaise conductivité thermique du Ga2 O3 Matériel. Dans ce rapport, les auteurs ont également souligné que α -(Rh,Ga)2 O3 peut agir comme une couche de canal de type p efficace de α -Ga2 O3 appareils.

Processus de fabrication du α -Ga2 O3 SBD proposé par FLOSFIA Inc. Réimprimé à partir de la réf. [18, 67]
En 2017, K. Konishi et al. en NTIC a signalé un Pt/HVPE-n − - Ga2 O3 /(001)n + - Ga2 O3 Dispositif SBD avec une tension de claquage de 1076 V et une résistance à l'état passant de 5,1 mΩ cm 2 (Fig. 9) [68]. L'ingénierie des plaques de champ (FP), une sorte de technologie de terminaison de bord, a été utilisée pour la première fois dans Ga2 O3 SBD. En ajoutant une anode connectée SiO2 FP, le champ électrique maximal dans toute la structure de l'appareil a été maintenu en dessous du champ critique, en particulier le champ électrique autour de l'anode peut être évidemment diminué. En utilisant cette méthode, il est possible d'obtenir à la fois une tension de claquage élevée et une faible résistance à l'état passant. La même année, une tension de claquage plus élevée (1600 V) a été signalée par J. Yang et al. de l'Université de Floride dans leur appareil SBD avec un Ni/MOCVD-n − - Ga2 O3 /(− 201) n + - Ga2 O3 structure [69], mais la résistance à l'état passant est très importante (25 mΩ cm 2 ). Aucune terminaison de bord n'a été utilisée. Leur enquête a montré que la taille de l'électrode Schottky avait une influence sur la tension de claquage et la résistance à l'état passant, car une électrode plus grande aurait plus de défauts et conduirait à une panne plus facile.
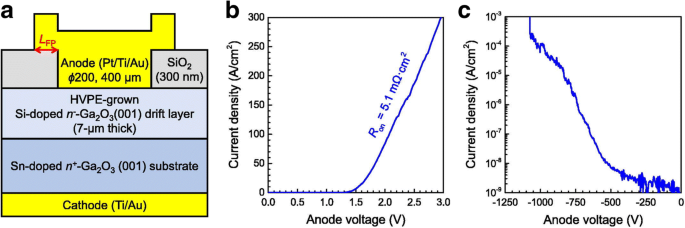
un Structure du SBD avec plaque de terrain. b , c Caractéristiques électriques avant et arrière (V br = 1076 V). Réimprimé de la réf. [68]
En 2017, K. Sasaki et al. from Novel Crystal Technology Inc. first fabricated β -Ga2 O3 SBD with trench termination structure (Fig. 10) [70]. By adopting this kind of structure, the electric field in the Schottky junction can be effectively decreased; thus, the leakage current can be greatly reduced while the forward properties are well maintained. The on-resistance of the device was 2.9 mΩ cm 2 , and the breakdown voltage reached about 240 V. At the same time, the threshold voltage was remarkably reduced compared with the previous reports. This work is a valuable exploration on the advanced fabrication process of Ga2 O3 SBD. In the 2nd International Workshop on Gallium Oxide and Related Materials (IWGO 2017) held in Italy, they further reported the improved trench SBD. The threshold voltage decreased to 0.5 V. On-resistance was 2.4 mΩ cm 2 , and breakdown voltage was over 400 V. Compared to the commercialized 600 V SiC SBD, the improved trench Ga2 O3 SBD exhibited superiority in switching loss.
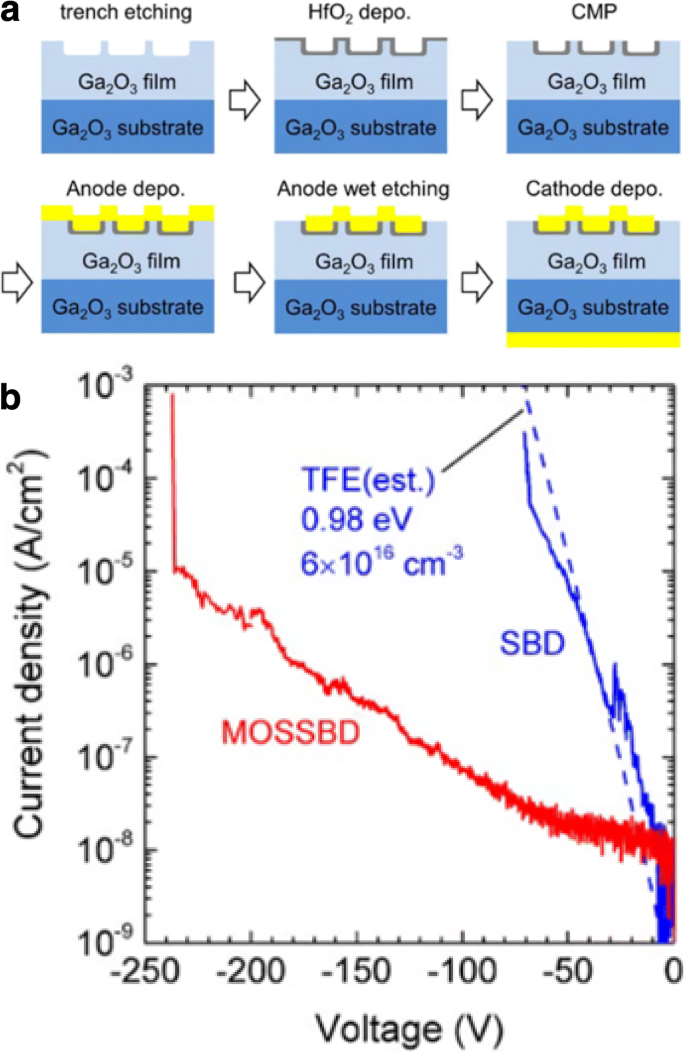
un Fabrication processes of the MOS-type Ga2 O3 SBD with trench termination structure. b Comparison of the reverse characteristics of the Ga2 O3 SBDs with and without trenches. Reprinted from ref. [70]
To date, there has been no effective p-type doping in Ga2 O3 , so bipolar devices are not easy to be realized. In 2017, T. Watahiki et al. from Mitsubishi Electric Corporation reported a heterojunction p-Cu2 O/n-Ga2 O3 p-n diode without local termination structure [71]. Figure 11 shows the schematic, band diagram and J–V curves of this p-n diode. Pt/Ga2 O3 SBD was simultaneously fabricated and measured for comparison. The breakdown voltage of the p-n diode reached as high as 1.49 kV. The on-resistance was 8.2 mΩ cm 2 , much lower than that of the SBD with a thick drift layer reported by J. Yang et al. [69]. So, it can be found that bipolar Ga2 O3 device has a certain advantage over unipolar device in regard to the low on-resistance. This work provides a possible solution for the design Ga2 O3 -based bipolar devices. However, this p-n diode exhibited a high threshold voltage (1.7 V). Moreover, in bipolar device, there is the minority carrier storage effect. With the improvement of SBD device structure, this p-n diode appears to show significant competitivity in the aspect of 600–1200 V voltage-resistant level and high frequency. It is believed that with the continuous exploration on the materials, SBD might still be a more effective approach for development of the high-voltage Ga2 O3 device before the successful preparation of p-type Ga2 O3 .
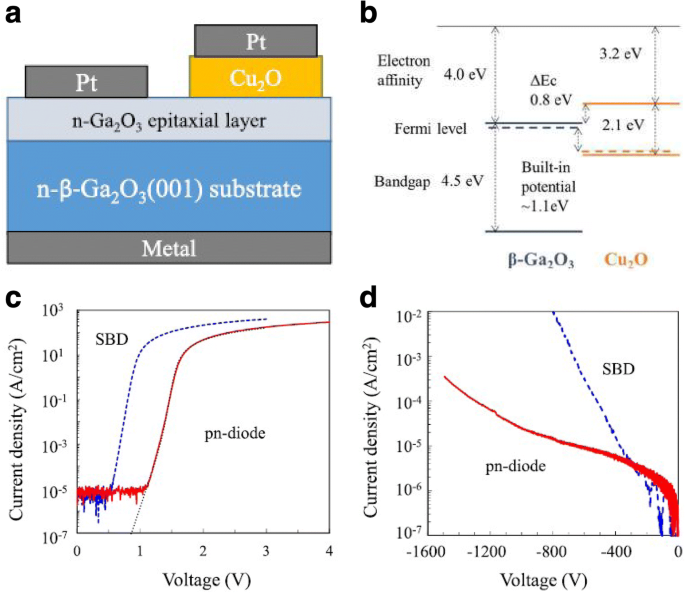
un Schematic of the cross-sectional Pt/Ga2 O3 SBD and p-Cu2 O/n-Ga2 O3 diode. b Band diagram of the p-Cu2 O/n-Ga2 O3 interface. c , d Forward and reverse J–V characteristics of the SBD and p-n diode. Reprinted from ref. [71]
In practical applications, SBD is usually used to rectify the AC or pulse signals as a rectifier in a circuit. It should work at different frequencies. Q. He et al. from IMECAS investigated the rectification characteristics of the Pt/Ga2 O3 SBD under the AC frequency under 10 kHz to 1 MHz by using a half-wave rectification circuit (Fig. 12) [63]. The testing result proves that the device has the ideal working frequency of 100 kHz, which is equivalent to that of SiC. This work is beneficial for people to further explore how Ga2 O3 Schottky rectifier can operate at higher frequency and also to construct power circuit modules based on Ga2 O3 SBD single device.

un Rectification circuit. b –e Rectifying effect of Pt/Ga2 O3 SBD on the AC signals under frequency of 10 kHz, 100 kHz, 500 kHz, and 1 MHz. Reprinted from ref. [63]
Table 2 lists and compares the basic performance parameters of some typical Ga2 O3 Schottky barrier diode reported since 2012. From this table, it is apparent that with the improvement of device structure and fabrication processes, the performances are getting better and better.
Conclusions
Currently, Ga2 O3 SBD is still in its early stage. With the continuous development of fabrication processes, device structure becomes more and more complicated. At the same time, the improvement of the quality of single-crystal substrates and epitaxial films also significantly push forward device performances. However, to date, the development process of Ga2 O3 SBD is very similar to those of previous Si SBD and SiC SBD. Furthermore, the research works on the intrinsic properties of Ga2 O3 materials are still very few. But it is believed that on the basis of its ultrawide bandgap of 4.7–4.9 eV and the development of device structure, Ga2 O3 will better display its unique application value, which requires the joint efforts of the researchers.
Abréviations
- AC:
-
Alternating current
- BFOM:
-
Baliga’s figure of merit
- CVD :
-
Dépôt chimique en phase vapeur
- EFG:
-
Edge-defined film-fed growth
- FFT :
-
Transformée de Fourier rapide
- FP :
-
Field plat
- FZ:
-
Floating zone
- HRTEM :
-
Microscopie électronique à transmission haute résolution
- HVPE:
-
Halide vapor-phase epitaxy
- IMECAS:
-
Institute of Microelectronics of Chinese Academy of Sciences
- MOCVD:
-
Metal-organic chemical vapor deposition
- MOSFET:
-
Metal-oxide-semiconductor field-effect transistor
- NICT:
-
National Institute of Information and Communications Technology
- PLD :
-
Dépôt laser pulsé
- SBD:
-
Schottky barrier diode
- TE :
-
Thermionic emission
- TFE:
-
Thermionic field emission
- WBG:
-
Wide bandgap
- XRD :
-
Diffraction des rayons X
Nanomatériaux
- Choisir les colorants à solvant de la meilleure qualité pour une application parfaite
- 10 facteurs pour trouver le commutateur parfait pour votre application
- Exploiter la puissance des villes intelligentes pour un avenir meilleur
- Dans l'électronique, l'Inde vise à devenir une « usine pour le monde »
- La recherche d'un groupe électrogène de rechange :4 questions vitales
- Les meilleures options de fabrication pour les boîtiers électroniques
- Un aperçu rapide des perspectives du marché des grues pour les années à venir
- Choisir le bon groupe électrogène pour votre entreprise
- Le bon matériau d'électrode pour votre application de soudage par résistance



