Résistance de contact réduite entre le métal et le n-Ge par insertion de ZnO avec traitement au plasma d'argon
Résumé
Nous étudions les contacts métal-isolant-semiconducteur sur n-Ge en utilisant une couche interfaciale (IL) de ZnO pour surmonter l'effet d'épinglage au niveau de Fermi (FLP) à l'interface métal/Ge et réduire la hauteur de barrière pour les électrons. Un petit décalage de bande de conduction de 0,22 eV à l'interface entre ZnO et n-Ge est obtenu, et le ZnO IL conduit à une résistance de contact significativement réduite (R c ) en métal/ZnO/n-Ge par rapport au dispositif de contrôle sans ZnO, du fait de l'élimination du FLP. Il est observé que le traitement plasma argon (Ar) du ZnO peut encore améliorer le R c caractéristiques dans le dispositif Al/ZnO/n-Ge, ce qui est dû au fait que le traitement au plasma d'Ar augmente la concentration en manque d'oxygène V o , agissant comme dopants de type n dans le ZnO. Le contact ohmique est démontré dans le Al/ZnO/n-Ge avec une concentration de dopant de 3 × 10 16 cm −3 en Ge. Sur le n + fortement dopé -Ge avec un ion phosphore (P + ) implantation, une résistivité de contact spécifique de 2,86 × 10 − 5 Ω cm 2 est atteint en Al/ZnO/n + -Ge avec le traitement plasma Ar.
Contexte
Le germanium (Ge) a beaucoup attiré l'attention sur les transistors à effet de champ (MOSFET) avancés en métal-oxyde-semiconducteur en raison de ses mobilités de porteurs plus élevées que celles du Si [1, 2]. Pour les MOSFET Ge à canal p, de grands progrès ont été réalisés dans la croissance du canal Ge contraint [3,4,5], la passivation de surface [6,7,8,9] et les contacts source/drain (S/D) [ 10], et les Ge pFinFETs ultra-échelle [11] ont démontré les performances électriques supérieures aux dispositifs Si. Les transistors Ge à canal n, en revanche, sont toujours confrontés à des défis, ce qui constitue un obstacle à l'intégration de Ge CMOS, notamment la mauvaise qualité de l'interface, entraînant une faible mobilité des électrons et la résistance S/D élevée en raison de l'activation limitée. taux de dopants de type n dans Ge [12] et l'épinglage au niveau de Fermi (FLP) à l'interface métal/n-Ge [13]. FLP conduit à une hauteur de barrière Schottky d'environ 0,5 eV pour les électrons pour la plupart des métaux sur n-Ge, produisant la très grande résistance de contact R c [13,14,15].
Le débrochage au niveau de Fermi peut être effectué en insérant une fine couche interfaciale (IL), par exemple, TiO2 [16] et ZnO [17], entre les métaux et le n-Ge [18], grâce au fait que l'IL mince peut bloquer la fonction d'onde métallique dans Ge pour réduire les états de gap induits par le métal [19, 20]. ZnO a un petit décalage de bande de conduction (CBO) par rapport à Ge, ce qui peut conduire à un R plus petit c en métal/ZnO/n-Ge, par rapport au métal/TiO2 /n-Ge avec TiO2 /Ge ayant le CBO positif [16]. La constante diélectrique du ZnO est inférieure à celle du TiO2 , donc ZnO IL peut obtenir une région d'appauvrissement plus mince entre le métal et le n-Ge par rapport à TiO2 . De plus, il est facile de réaliser un dopage de type n dans le ZnO en introduisant des défauts non stoechiométriques, tels que des lacunes d'oxygène V o [21, 22], ce qui donne lieu à une région d'appauvrissement en ZnO encore plus petite entre le métal et le n-Ge. Jusqu'à présent, dans les contacts métal/ZnO/n-Ge, le dopage du ZnO par V o a été réalisée par recuit dans une atmosphère d'azote [16], ce qui pourrait cependant entraîner l'interdiffusion de ZnO et Ge pendant le recuit [23], et la diffusion d'atomes de dopant dans n-Ge pendant le recuit [24, 25], provoquant la dégradation des performances actuelles de l'appareil. Depuis, un procédé de dépôt et de dopage de ZnO à basse température doit être développé.
Dans ce travail, nous étudions le dépilage au niveau de Fermi à l'interface entre le métal et le n-Ge par insertion d'ALD déposé ZnO IL. Les effets d'amélioration du traitement plasma à l'argon (Ar) de la couche de ZnO sur les caractéristiques de résistance de contact de l'Al/ZnO/n-Ge sont étudiés.
Méthodes
Des contacts métalliques ont été formés sur des plaquettes de n-Ge (001) légèrement et fortement dopées. Les échantillons de Ge légèrement dopés ont une concentration de dopage d'environ 3 × 10 16 cm −3 . Pour obtenir le n-Ge fortement dopé, un ion phosphore (P + ) implant avec une dose de 1 × 10 15 cm −2 et une énergie de 30 keV a été réalisée sur le n-Ge(001), qui a été suivi d'un recuit thermique rapide à 600 °C pendant 60 s. Après le nettoyage des plaquettes à l'aide de plusieurs cycles d'eau déminéralisée et de HCl dilué, les plaquettes de Ge ont été immédiatement chargées dans une chambre ALD (Beneq TSF-200) pour déposer du ZnO, puis des contacts en aluminium (Al) ont été déposés par pulvérisation sur Ge en utilisant un processus de décollement. . Ici, trois épaisseurs de ZnO de 1, 2 et 3 nm ont été utilisées, ce qui a été confirmé par ellipsométrie spectroscopique (SE) (J. A. Woollam M2000). Lors du dépôt de ZnO, le diéthyl zinc (DEZn) et l'eau déminéralisée (H2 O) ont été utilisés comme précurseurs de Zn et O, respectivement, et la température du substrat a été maintenue à 150 °C pour éliminer la formation de GeOx . Le processus de dépôt de ZnO détaillé à l'aide d'ALD a été rapporté dans nos travaux précédents dans la réf. [26, 27]. Pour améliorer encore la conductivité du film de ZnO, certains échantillons de ZnO sur Ge ont été traités avec un plasma d'argon (Ar). Un échantillon témoin Al/n-Ge sans ZnO IL a également été fabriqué. Le R c d'Al sur ZnO/Ge a été extrait en utilisant la méthode de la ligne de transmission circulaire (CTLM), qui a été formée par lift-off. Le ZnO exposé a été entièrement gravé par gravure plasma pour assurer une isolation complète entre les dispositifs adjacents [16].
Keithley 4200 SCS a été utilisé pour mesurer les caractéristiques électriques des contrats Al/ZnO/n-Ge et des structures CTLM, un microscope électronique à transmission haute résolution (HRTEM) et une spectroscopie photoélectronique à rayons X (XPS) ont été utilisés pour déterminer la microstructure et l'interface propriétés des échantillons, et le spectrophotomètre UV-VIS (LAMBDA 950, PerkinElmer) a été utilisé pour déterminer la bande interdite E g de film de ZnO déposé.
Résultats et discussion
Caractérisation du matériau Al/ZnO/n-Ge
Les spectres de bande de valence XPS de Ge/ZnO et le spectre de transmittance de ZnO sont présentés dans les Fig. 1 et 2, respectivement, qui ont été utilisées pour étudier le mécanisme de l'effet de dépinçage au niveau de Fermi à l'interface Al/ZnO/n-Ge. Nous avons effectué les mesures XPS pour l'échantillon de ZnO épais, l'échantillon d'interface ZnO/n-Ge et l'échantillon de Ge pur, pour obtenir le décalage de bande de valence (VBO) de ZnO/Ge, comme le montre la figure 1. Le Zn 2 p la position de crête et le VBM pour un échantillon de ZnO épais sont respectivement de 1021,9 eV et 2,59 eV. Le Zn 2p et Ge 3d la position de crête pour l'échantillon d'interface ZnO/Ge est respectivement de 1021,7 eV et 29,1 eV. Le Ge 3d la position de crête et le VBM pour l'échantillon de Ge pur sont respectivement de 29 eV et 0,06 eV. Cela indique que le VBO de ZnO/Ge est de 2,33 eV [30].

Spectres XPS pour les bandes de valence de l'échantillon ZnO/Ge. un Zn 2p et b spectres de bande de valence pour échantillon de ZnO épais c ZnO 2p et d Ge 3d spectres pour l'échantillon d'interface ZnO/Ge et e Ge 3d et f spectres de bande de valence pour l'échantillon Ge en vrac
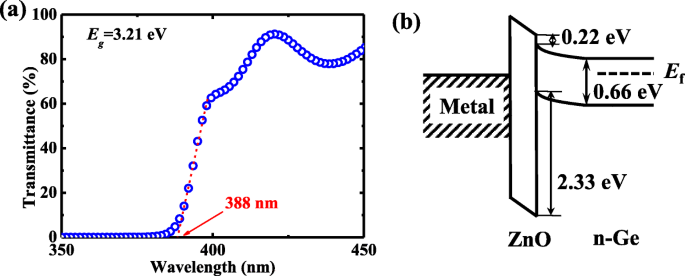
un Spectre de transmission pour le film de ZnO déposé démontrant le E g de 3,21 eV. b L'alignement de la bande pour le contact Al/ZnO/Ge
La figure 2a montre le tracé de la transmittance obtenu à partir de la spectroscopie UV-VIS pour un échantillon de ZnO épais et le E g de ZnO est déterminé à 3,21 eV, ce qui correspond aux valeurs rapportées dans [28, 29]. En utilisant le E obtenu g de ZnO et VBO ci-dessus, un CBO de 0,22 eV entre ZnO et Ge est déterminé, comme le montre la figure 2b. Cela indique que le débrochage au niveau de Fermi peut être réalisé à l'interface Al/n-Ge en utilisant la couche d'insertion ZnO, qui peut produire le faible R c pour contact Al/ZnO/n-Ge.
La figure 3 montre l'image MET de la structure Al/ZnO/n-Ge avec une épaisseur de ZnO de 3 nm. Une couche de ZnO uniforme et conforme est observée entre Al et n-Ge. L'encart dans le coin supérieur droit illustre l'image HRTEM de la vue agrandie de l'interface Al/ZnO/n-Ge. L'épaisseur du film de ZnO est mesurée à 3 nm, ce qui est cohérent avec le résultat obtenu par mesure SE, et le film de ZnO est sous une forme amorphe.
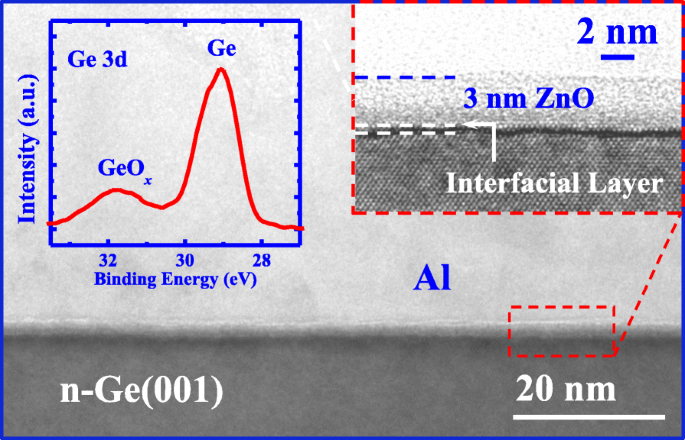
Image MET pour un échantillon Al/ZnO/n-Ge montrant la couche uniforme de ZnO entre Al et Ge. L'encart en haut à droite montre l'image HRTEM de l'interface Al/ZnO/n-Ge, et l'encart en haut à gauche montre le XPS Ge 3d résultat de l'échantillon démontrant l'existence de GeOx couche interfaciale
Un GeOx mince couche interfaciale est formée entre Ge et ZnO, qui est beaucoup plus petite par rapport à [31] en raison de la température de dépôt inférieure utilisée dans ce travail. Ceci est attribué au fait que, lors du dépôt de ZnO, Ge réactif avec O précurseur, conduisant à la formation de GeOx IL. GeOx est également démontré par le XPS Ge 3d résultat dans l'encart dans le coin supérieur gauche.
La conductivité électrique du film de ZnO peut être améliorée par le traitement au plasma Ar, ce qui provoque l'augmentation de la concentration des lacunes d'oxygène V o , agissant en tant que donneurs de ZnO [32, 33]. La figure 4 illustre les résultats XPS de O 1s pour le ZnO tel que déposé et l'échantillon avec un traitement au plasma Ar avec une puissance de 50 W, un débit de gaz Ar de 60 sccm et une durée de 45 s. Les O 1s pic est déconvolué en deux pics en utilisant l'ajustement gaussien. Le pic à ~ 530 eV correspond à l'oxygène du réseau dans le ZnO [34, 35]. Pour l'échantillon tel que déposé, le pic à 531,7 eV correspond à V o (~ 531,5 eV) et de l'oxygène chimisorbé à la surface des films minces de ZnO, tels que les groupes carbonyle et hydroxyle [35, 37]. Pour l'échantillon avec traitement au plasma d'Ar, le pic est à ~ 531,5 eV, ce qui passe à une énergie de liaison plus faible, et devient beaucoup plus prononcé par rapport à l'échantillon tel que déposé, indiquant que plus de V o sont générés en raison du traitement au plasma d'Ar, et l'oxygène chimisorbé est efficacement éliminé. L'augmentation des dopants de type n dans le ZnO entraîne une barrière tunnel plus fine et une résistance série plus faible à l'interface, ce qui est responsable de la réduction de R c [36].

Résultats XPS de O 1s et les résultats déconvolués pour les échantillons de ZnO (3 nm)/n-Ge tels que déposés (en haut) et traités au plasma d'Ar (en bas)
Nous avons effectué les mesures XPS en utilisant un échantillon de ZnO épais et un échantillon d'interface ZnO/Ge avec et sans traitement au plasma Ar, comme le montre la Fig. 5. Nous avons constaté qu'après le traitement au plasma Ar, il y avait un décalage de − 0,05 eV. Cela peut indiquer que le VBO ZnO/Ge est d'environ 2,38 eV après le traitement au plasma Ar et le CBO de 0,17 eV.

VBM pour échantillon d'interface ZnO/Ge avec et sans traitement plasma Ar. un Zn 2p et b spectres de bande de valence pour échantillon de ZnO épais c ZnO 2p spectres pour l'échantillon d'interface ZnO/Ge. d Diagramme d'alignement des bandes pour métal traité au plasma Ar/ZnO/n-Ge
Performances électriques des contacts Al/ZnO/n-Ge
La figure 6a montre la densité de courant mesurée J en fonction de la tension appliquée V caractéristiques des contacts Al sur n-Ge faiblement dopé. Le Al/ZnO/n − -Les appareils Ge ont les différentes épaisseurs de couche de ZnO. Le schéma de l'appareil est présenté dans l'encart de la Fig. 6.
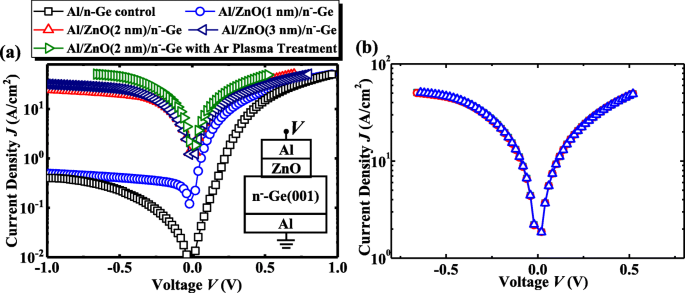
un J -V caractéristiques pour Al/n − -Contrôle Ge, Al/ZnO/n − -Ge avec des épaisseurs de ZnO de 1 nm, 2 nm et 3 nm, et ZnO/Ge traité au plasma d'Ar Al/2 nm, b J Caractéristiques -V pour trois dispositifs ZnO/Ge traités au plasma Al/2 nm Ar
Comme prévu, le dispositif de contrôle Al/n-Ge sans ZnO montre les caractéristiques de redressement avec la hauteur de barrière élevée pour les électrons en raison de l'épinglage du niveau de Fermi à Al/n − -Ge [38]. Par rapport à l'échantillon témoin Al/n-Ge sans ZnO, les dispositifs Al/ZnO/n-Ge présentent l'amélioration J inverse , ce qui est dû au dépinning au niveau de Fermi induit par la réduction des états d'espacement induits par les métaux (MIGS) à l'interface métal/Ge [18, 19]. Cette amélioration est plus accentuée avec du ZnO plus épais, ce qui est dû au fait que plus de MIGS sont éliminés. Mais la densité de courant directe pour le dispositif inséré à 3 nm de ZnO est inférieure à celle d'un appareil à 2 nm. Cela peut s'expliquer comme suit. La densité de courant principale pour Al/ZnO/n-Ge est le courant tunnel. Si le ZnO n'est pas assez épais, le MIGS ne sera pas éliminé efficacement et il présente toujours des caractéristiques de redressement. Mais si le ZnO est trop épais, la résistance série du ZnO dominera toute la résistance et le courant diminue. Il y a donc un compromis entre l'élimination du MIGS et l'augmentation de la résistance série du ZnO, et donc il y a une épaisseur critique pour l'IL [19]. En conclusion, 2 nm est considéré comme l'épaisseur optimale pour le contact Al/ZnO/n-Ge.
Avec le traitement plasma Ar, les performances de Al/ZnO/n − -Ge dispositif est encore amélioré. Que ce soit pour le balayage inverse ou direct de la tension appliquée V , Al/2 nm ZnO/n − -L'appareil Ge avec traitement au plasma Ar atteint le J amélioré par rapport à l'appareil avec 2 nm de ZnO ou 3 nm de ZnO, ce qui est dû à une grande quantité de V o sont générés dans le film de ZnO pendant le traitement au plasma d'Ar. La concentration de dopage plus élevée en ZnO peut réduire efficacement la résistance série du ZnO et réduire la barrière tunnel pour les électrons à l'interface entre ZnO et Al, améliorant ainsi la densité de courant tunnel.
La figure 6b montre J -V caractéristiques pour trois Al/2 nm ZnO/n − -Appareil Ge avec traitement plasma Ar. Il est clair que le J pour différents appareils est presque le même, ce qui indique que le processus ALD et le traitement au plasma Ar ont un effet uniforme sur l'amélioration de la densité de courant.
Les contacts ohmiques sont obtenus pour le Al/2 nm ZnO/n − -Ge sans et avec différentes durées de traitement au plasma Ar de 15 s, 30 s, 45 s et 60 s, respectivement, qui sont illustrées à la Fig. 7.

Je –V courbes à Al/2 nm ZnO/n − -Ge avec différents d un sans traitement plasma Ar et avec traitement plasma Ar durée de b 15 s, c 30 s, j 45 s, et e 60 s
La résistance totale brute R tot entre deux contacts diminue avec la diminution de d , et le dernier R tot est modifié par un facteur de correction C, qui est calculé avec l'équation C = (L /d )·ln(1 + d /L ) [39], où L = 25 μm représente le rayon du coussinet intérieur, comme illustré dans l'encart de la Fig. 8a. En traçant le R tot en fonction de d dans la Fig. 8a, la résistance de feuille R ch du n − -Ge peut être obtenu à partir de la pente de la ligne, puis ρ c est calculé à partir de l'intersection de la ligne d'ajustement linéaire avec l'axe vertical. Pour le Al/2 nm ZnO/n − -Appareil Ge sans traitement plasma Ar, le ρ c est 6,87 × 10 −2 Ω cm 2 , mais après 45 s de traitement au plasma Ar, il y a une réduction de 17,2 fois par rapport à celle sans traitement au plasma Ar et a la résistivité de contact ρ c de 3,66 × 10 −3 Ω cm 2 . Nous comparons les valeurs de ρ c pour le Al/2 nm ZnO/n − -Dispositifs Ge avec différentes durées de traitement au plasma Ar sur la Fig. 8b. On observe que ρ c de l'appareil diminue avec le temps de traitement jusqu'à 30 s. Cependant, comme le temps de traitement est supérieur à 30 s, ρ c reste presque le même. La réduction de ρ c peut être attribué au dopage du ZnO, donc à la réduction de la barrière tunnel et de la résistance série, comme cela a été mentionné précédemment. Mais il n'y a pas de changement observable dans la résistance de couche de n − -Ge, indiquant qu'il n'y a aucun effet sur la conductivité de n − -Ge avec le traitement plasma Ar.
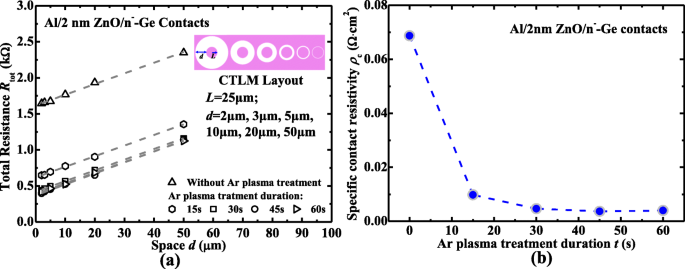
un R tot contre d courbes pour le CTLM avec Al/2 nm ZnO /n − -Ge contacts avec différentes durées de traitement au plasma Ar, l'encadré sur la figure 5a est l'information de la structure CTLM utilisée dans ce travail. b ρ c par rapport à différentes durées de traitement au plasma Ar
La structure CTLM avec contacts Al sur Ge fortement dopé est utilisée pour étudier la caractéristique de résistance de contact de Al/2 nm ZnO/n + -Ge. La couche de ZnO a subi un traitement plasma Ar pendant 45 s. La figure 9a montre le I mesuré -V courbes entre les contacts Al avec différents d , montrant l'excellente performance ohmique. La figure 9b représente le R tot en fonction de d pour Al/2 nm ZnO/n + -Ge CTLM, et R ch et ρ c sont extraits à 64 Ω/□ et 2,86 × 10 −5 Ω cm 2 , respectivement.
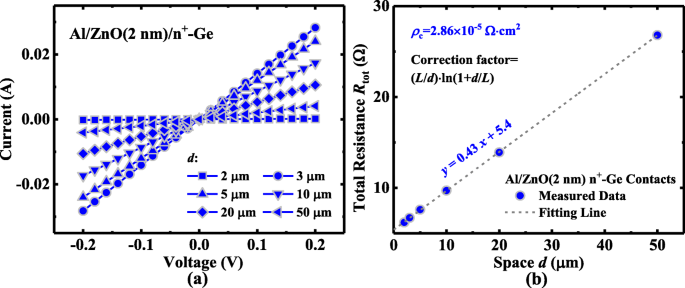
un Je –V courbes à Al/ZnO(2 nm)/n + -Ge avec différents d avec du ZnO traité par plasma d'Ar. b R tot contre d courbes pour le CTLM avec Al/ZnO(2 nm)/n + -Ge contacts
Nous comparons les ρ c de ZnO traité par plasma Ar Al/ZnO/n + -Les dispositifs Ge dans ce travail avec ceux rapportés dans la littérature, comme le montre la Fig. 10. Pour le n + fortement dopé -Ge échantillon de contact, Al/ZnO/n + -Ge contacts montré le plus petit ρ c en comparaison avec celles de Ni/GeSn [40, 41], Ni/Ge [42], Ti/n + -Ge en réf. [31], et Ti/TiO2 /GeO2 /Ge [31], Ni/Ge [42] implanté en carbone et Ti/n + -SiGe/n-Ge [43]. Les contacts ohmiques métalliques tels que Ni/Ge, Ni/GeSn, Ti/Ge et les Ni/Ge implantés en carbone souffrent d'un grave accrochage au niveau de Fermi, ce qui entraîne le grand ρ c . Pour Ti/TiO2 /GeO2 /Ge contact, une grande résistance tunnel a été introduite par la bicouche de 1 nm TiO2 /1,5 nm GeO2 IL, dégradant les caractéristiques de résistivité de contact. Mais le ρ c dans ce travail est plus grand que celui de la réf. [44]. Nous supposons que cela peut être dû au P + quatre fois plus grand dose d'implantation que celle de notre travail. Une dose d'implantation plus importante permettra un dopage de surface plus important de n + -Ge, résultant en une barrière Schottky plus mince et un ρ plus petit c . Nous pensons qu'avec un dopage plus important de n + -Ge en Al/ZnO/n + -Ge appareils, plus petits ρ c en résultera.
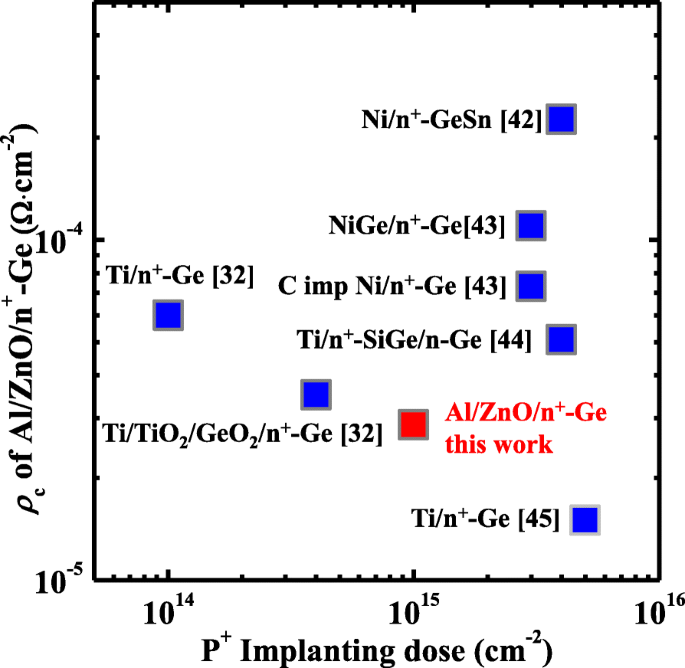
Comparaison de ρ c de Al/ZnO/n + -Ge dans ce travail avec ceux d'autres contacts signalés, en utilisant P + dose d'implantation en tant que x axe
Conclusions
L'effet de dépilage au niveau de Fermi induit par ZnO IL dans les structures Al/ZnO/n-Ge est étudié. La mesure XPS a démontré un petit CBO de 0,22 eV à ZnO/n-Ge, c'est-à-dire qu'une élimination de FLP se produit, ce qui conduit aux contacts métalliques ohmiques sur n-Ge. Il est en outre rapporté que le traitement plasma Ar de ZnO conduit à l'augmentation de la concentration de V o , agissant comme dopants de type n dans ZnO, ce qui améliore le R c performances dans les appareils Al/ZnO/n-Ge. Des contacts métalliques ohmiques sont obtenus sur n − et n + -Ge avec le ZnO IL traité au plasma Ar. Sur la base des structures CTLM, les valeurs de ρ c 3.66 × 10 −3 Ω cm 2 et 2,86 × 10 − 5 Ω cm 2 sont obtenus en Al/2 nm ZnO/n − -Ge et Al/2 nm ZnO/n + -Ge, respectivement, avec le traitement plasma Ar de ZnO à une puissance de 50 W pendant 45 s.
Abréviations
- Al :
-
Aluminium
- ALD :
-
Dépôt de couche atomique
- Ar :
-
Argon
- CBO :
-
Décalage de la bande de conduction
- CTLM :
-
Méthode de ligne de transmission circulaire
- DEZn :
-
Diéthylzinc
- E g :
-
Bande interdite
- FLP :
-
Épinglage au niveau de Fermi
- Voir :
-
Germanium
- GeOx :
-
Oxyde de Germanium
- GeSn :
-
Étain germanium
- HCl :
-
Acide chlorhydrique
- HRTEM :
-
Microscope électronique à transmission haute résolution
- IL :
-
Couche interfaciale
- MIGS :
-
États d'espacement induits par le métal
- MOSFET :
-
Transistors à effet de champ métal-oxyde-semiconducteur
- Non :
-
Nickel
- P + :
-
Ion phosphore
- R c :
-
Résistance de contact
- R tot :
-
Résistance totale brute
- SE :
-
Ellipsométrie spectroscopique
- Si :
-
Silicium
- Ti :
-
Titane
- TiO2 :
-
Dioxyde de titane
- UV-VIS :
-
Ultraviolet-visible
- VBO :
-
Décalage de la bande de valence
- V o :
-
Vacance d'oxygène
- XPS :
-
Spectroscopie photoélectronique aux rayons X
- ZnO :
-
Oxyde de zinc
- ρ c :
-
Résistivité de contact spécifique
Nanomatériaux
- Quelle est la différence entre l'Inconel et l'Incoloy ?
- Quelle est la différence entre une tôle, une plaque et une feuille ?
- Différence entre structure et classe :expliquée avec un exemple C++
- Différence entre while et do-while :expliquée avec des exemples
- Réglage de la chimie de surface du polyétheréthercétone par revêtement d'or et traitement au plasma
- Qu'est-ce que le traitement thermique ? - Processus et méthodes
- Quelle est la différence entre la fabrication de métaux et le soudage de métaux ?
- Quelle est la différence entre la fabrication métallique et le soudage ?
- La différence entre le revenu et le recuit



