Impacts du dopage au Cu sur les performances des dispositifs RRAM basés sur La
Résumé
Dans cet article, les effets de la couche d'insertion de Cu et du recuit thermique rapide sur les comportements de commutation résistive des dispositifs de mémoire à accès à commutation résistive (RRAM) à base de La ont été étudiés. Par rapport à l'échantillon témoin non dopé (Cu/LaAlO3 /Pt), les dispositifs intégrés au Cu présentent un rendement de dispositif et une tension d'arrêt de réinitialisation plus élevés, ce qui indique que la fiabilité de la RRAM basée sur La a été efficacement améliorée. Cependant, le Cu/LaAlO3 non recuit :Le dispositif Cu/Pt RRAM souffre toujours d'une grave dispersion des paramètres. Il a été prouvé que le dispositif RRAM avec couche d'insertion de Cu et traitement de recuit présente les meilleures caractéristiques de commutation résistive telles qu'une faible tension de formation, un rapport marche/arrêt élevé et une uniformité électrique fine. Ces améliorations peuvent être attribuées à la diffusion des atomes de Cu et à la formation de nanocristaux de Cu (Cu-NC) après le processus de recuit, car les atomes de Cu diffusés et les Cu-NC pourraient augmenter le champ électrique local et affaiblir le caractère aléatoire de la formation/ rupture de filaments conducteurs.
Introduction
La mémoire à accès aléatoire résistive (RRAM) est considérée comme une direction de développement pour les dispositifs de mémoire non volatile de nouvelle génération, qui ont beaucoup attiré l'attention en raison de sa structure simple, de sa faible consommation d'énergie, de sa grande évolutivité, de sa vitesse de fonctionnement rapide et de sa valeur multiple. capacité de stockage [1]. La RRAM est souvent fabriquée dans une structure sandwich métal-isolant-métal (M-I-M), et la couche diélectrique intermédiaire a une influence significative sur ses performances de commutation résistive (RS). Ainsi, une grande variété de matériaux, y compris de nombreux couramment utilisés à constante diélectrique élevée (haute-k ) matériaux (tels que HfO2 [2], Al2 O3 [3], et ZrO2 [4]), ont été largement étudiés pour les applications RRAM. Parmi tous les matériaux d'oxyde, l'oxyde à base de lanthane est l'un des plus prometteurs à k élevé. matériaux diélectriques, qui a suscité de grands intérêts de recherche en raison de son haut-k valeur, large bande interdite et stabilité thermique fine [5]. Récemment, de bonnes caractéristiques de commutation de résistance, telles qu'une faible tension de fonctionnement, une fenêtre de résistance élevée, un long temps de maintien, une longue endurance de cycle et une bonne cohérence, ont été trouvées dans les RRAM à base de La, indiquant l'application potentielle de haute-k matériaux dans les RRAM [6, 7].
De plus, en raison des avantages d'une excellente uniformité, d'un contrôle précis de l'épaisseur et de la compatibilité avec le processus CMOS, la technologie de dépôt de couche atomique (ALD) a été l'une des méthodes de croissance les plus couramment utilisées pour produire des films diélectriques à base de La [8]. Malheureusement, des tensions de formation élevées indésirables sont toujours nécessaires dans les dispositifs RRAM déposés par ALD en raison des films diélectriques de bonne qualité, ce qui peut entraîner un taux de défaillance élevé, un faible rapport marche/arrêt, une faible endurance et une large dispersion des dispositifs [9] . Afin d'obtenir des dispositifs RRAM avec de meilleures performances RS, l'ingénierie de la structure des matériaux/dispositifs, y compris l'implantation d'ions [10], la diffusion de dopants [11] ou l'insertion de nanocristaux (NC) [12], doivent être adoptées dans le La préparé par ALD. -basées sur des RRAM.
Dans des rapports récents, différentes technologies de dopage pour améliorer les comportements RS du haut-k traditionnel matériaux (HfO2 [13], ZrO2 [14], etc.) ont été largement étudiées. Cependant, les comportements RS améliorés par NC des périphériques RRAM basés sur La n'ont pas été signalés jusqu'à présent. Ainsi, un LaAlO3 Cu-embarqué dispositif avec la structure de Cu/LaAlO3 /Cu/LaAlO3 /Pt est fabriqué pour l'application mémoire, et l'attention s'est concentrée sur les impacts du dopage au Cu sur les performances et le mécanisme de commutation des dispositifs RRAM basés sur La.
Méthodes
Le schéma de principe du dispositif fabriqué avec la structure de Cu/LaAlO3 /Cu/LaAlO3 /Pt est représenté sur la figure 1. Le processus de fabrication du dispositif RRAM à base de La est le suivant :un métal bicouche, 100 nm Pt/10 nm Ti, a d'abord été déposé sur un 2-in. SiO2 Plaquette de /Si comme électrode inférieure (BE) par évaporation par faisceau d'électrons. Par la suite, la température du réacteur Picosun R-150 ALD a été fixée à 300 °C et à ~ 10 nm de LaAlO3 (rapport La/Al de 3:1) un film mince a été déposé sur le Pt/Ti/SiO2 /Si substrats, en utilisant La( i- PrCp)3 comme précurseur La, Al(CH3 )3 comme précurseur Al et O3 comme oxydant. Ensuite, une couche de Cu ~ 2 nm a été cultivée sur le LaAlO3 à une vitesse de 0,1 Å/s à l'aide d'un évaporateur à faisceau d'électrons (EBE). Encore une fois, ~ 10 nm LaAlO3 (rapport La/Al de 3:1) un film mince a été déposé par ALD à 300°C. Après le LaAlO3 /Cu/LaAlO3 couche de commutation avait été préparée en utilisant le procédé ALD-EBE-ALD, le procédé de recuit thermique rapide (RTA) a été réalisé dans un N2 ambiante à 600 °C pendant 30 s. L'électrode supérieure (TE) de 10 nm Au/150 nm Cu a été déposée sur le LaAlO3 diélectrique par évaporation par faisceau d'électrons après lithographie, et suivi d'un décollement pour fabriquer des dispositifs ayant des tailles allant de 50 × 50 μm 2 à 250 × 250 μm 2 . Afin de mieux comprendre les impacts du dopage au Cu sur les performances des dispositifs RRAM à base de La, deux échantillons de contrôle, S1 :Au/Cu/LaAlO3 /Pt (non recuit) et S2 :Au/Cu/LaAlO3 :Cu/Pt (non recuit), ont été mis en place. Et l'échantillon avec Au/Cu/LaAlO3 :La structure Cu-NC/Pt a été assignée comme S3.
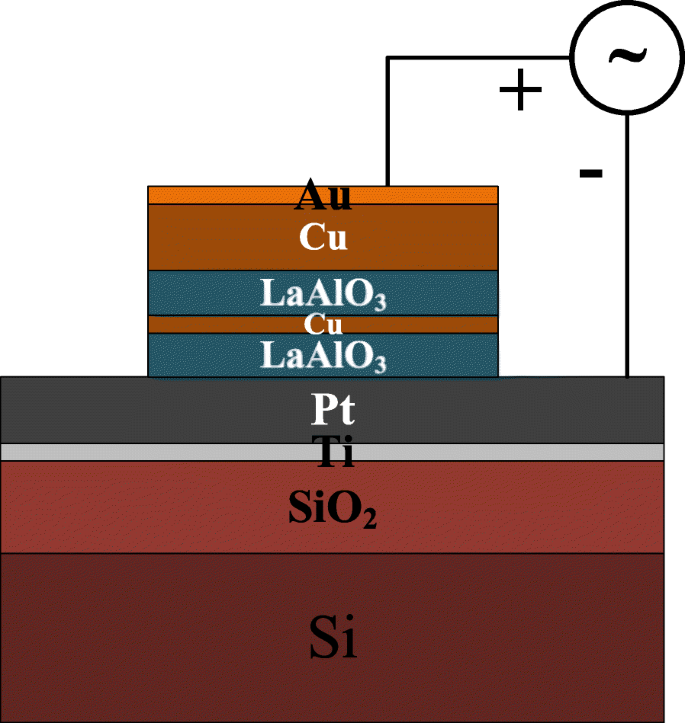
Schéma de principe de LaAlO3 Cu-encastré dispositif avec la structure de Cu/LaAlO3 /Cu/LaAlO3 /Pt
La spectroscopie photoélectronique aux rayons X (XPS) a été utilisée pour analyser la distribution des atomes de Cu dopés et la microscopie électronique à transmission transversale (MET) a été utilisée pour observer la microstructure des dispositifs RRAM fabriqués. Les propriétés RS ont été mesurées sous différents modes à l'aide d'un analyseur de paramètres à semi-conducteur Agilent B1500A. Une conformité de courant de 1 mA a été imposée pour protéger les unités de dispositifs fabriquées contre les dommages causés par des courants élevés pendant les processus de formage et de prise.
Résultats et discussion
La figure 2 montre l'analyse en profondeur par spectroscopie photoélectronique aux rayons X (XPS) des spectres Cu 2p dans le LaAlO3 dopé Cu. film (Paramètres de gravure :2 KVM Ar ion, taux de gravure ~ 1 Å/s). Comme on peut le voir sur la figure 2, le pic Cu 2p peut difficilement être trouvé dans l'échantillon non recuit (S2) après une gravure pendant 30 s ou 60 s, tandis qu'après une gravure pendant 90 s, un pic Cu 2p notable apparaît, indiquant que le Cu les atomes se concentrent principalement dans la couche enrobée de Cu. Différemment, les atomes de Cu sont observés dans l'ensemble LaAlO3 film après traitement de recuit, c'est-à-dire après gravure pendant 30 s, 60 s et 90 s, des pics évidents de Cu 2p peuvent être observés dans S3. Les résultats XPS confirment que le recuit à haute température conduira à une redistribution des atomes de Cu dopés, ce qui peut aider à améliorer les caractéristiques électriques des RRAM à base de La.
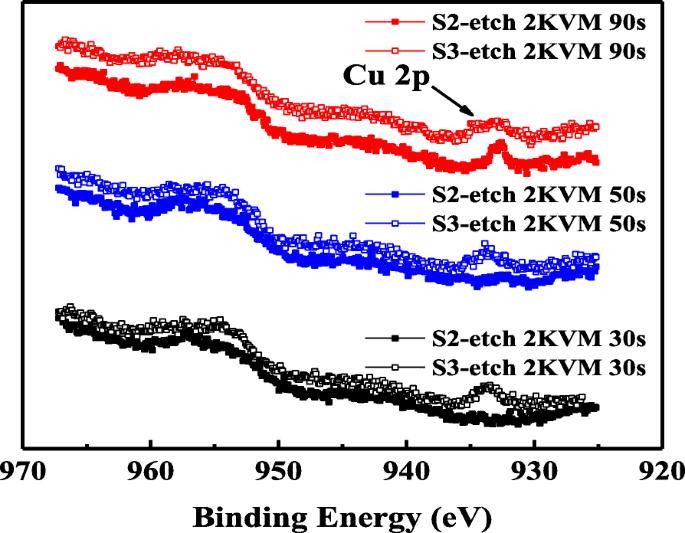
Résultats XPS des spectres Cu 2p pour S2 et S3 après gravure ionique Ar pendant 30 s, 60 s et 90 s
La figure 3 montre l'image typique au microscope électronique à transmission (MET) en coupe transversale des deux LaAlO3 enrobés de Cu. RRAM (c'est-à-dire S2 et S3). Comme le montre la figure 3a, la structure stratifiée du Cu/LaAlO3 non recuit /Cu/LaAlO3 Le dispositif /Pt a pu être reconnu clairement dans l'image TEM de S2. Il est à noter qu'après le dépôt de la partie supérieure LaAlO3 couche à 300°C du procédé ALD, la nanocouche de Cu intégrée de ~ 2 nm a été légèrement affectée par la diffusion thermique. Par conséquent, à partir de l'image haute résolution de la figure 3b, les nanoparticules de Cu irrégulières et séparées d'une taille de 2 à 6 nm intégrées dans LaAlO3 couche peut être clairement observée. Le traitement de recuit supplémentaire après le processus ALD améliorerait encore la diffusion thermique des atomes de Cu, rendant difficile la distinction de l'existence d'une nanocouche de Cu, comme le montre la figure 3c. Avec l'aide d'une image TEM à plus haute résolution, comme le montre la figure 3d, un LaAlO3 d'environ 25 nm d'épaisseur une couche incrustée de plusieurs Cu-NC sphériques et séparées a pu être observée, indiquant qu'une partie de la nanocouche de Cu a déjà diffusé dans le LaAlO3 diélectrique avec quelques Cu-NC de plus petite taille restant après un traitement de recuit à 600 °C.
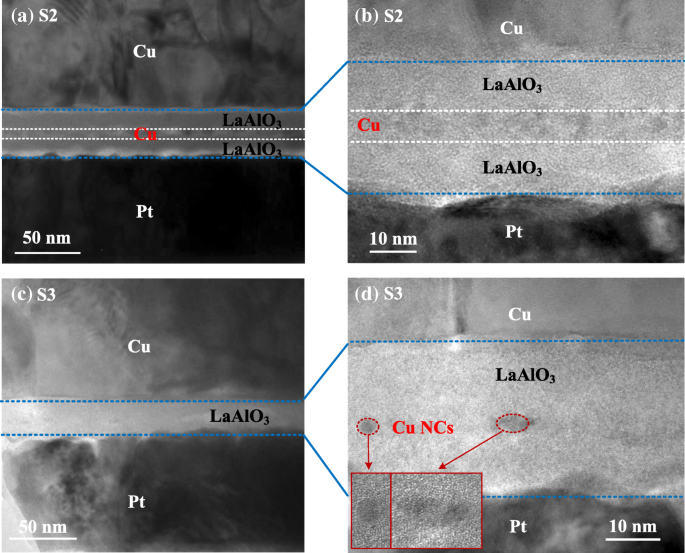
Images TEM des dispositifs RRAM Cu-embedded. un Une image MET en coupe transversale typique de S2. b Une image HRTEM de S2. c Une image MET en coupe de S3. d Une image HRTEM de S3
Le processus de formation électrique des échantillons S1, S2 et S3 est illustré sur la figure 4. Comme on peut le voir sur la figure 4, une tension élevée d'environ 12 V est requise dans le processus de formation de S1, et une tension de formation beaucoup plus faible. (~ 7 V) est nécessaire dans S2 et S3, montrant que la tension de formation des dispositifs à base de La peut être efficacement réduite en insérant une nanocouche de Cu dans le film diélectrique. De plus, par rapport à la valeur de résistance initiale de S1 (2,51 × 10 12 Ω, lu à 1 V), la résistance de S2 est beaucoup plus faible (2,65 × 10 6 Ω, lu à 1 V), et cette valeur augmente après le processus de recuit (S3, 2,83 × 10 12 Ω, lu à 1 V). Les variations ci-dessus de la tension de formation et de la résistance initiale peuvent être attribuées aux changements des propriétés diélectriques de LaAlO3 films grâce à l'ingénierie des matériaux/de la structure de l'appareil. En raison de l'excellente qualité des films diélectriques à base de La préparés par la méthode ALD, une intensité de champ électrique extrêmement élevée est nécessaire pour briser l'isolant (c'est-à-dire S1). Une fois que la nanocouche de Cu a été insérée dans le film diélectrique, la couche de commutation de haute qualité cultivée par ALD sera affectée par cette nanocouche métallique, ce qui rendrait le diélectrique plus facile à décomposer et conduirait finalement à une tension de formation beaucoup plus faible dans S2. En outre, la barrière énergétique de la formation de lacunes d'oxygène pourrait être efficacement diminuée et des défauts plus métastables seraient introduits dans le film diélectrique en raison des différences structurelles entre Cu et LaAlO3 matériaux (match de treillis, match de dilatation thermique, etc.) [15]. Par conséquent, un plus grand nombre de défauts (pièges à charges, ions métalliques, lacunes d'oxygène, etc.) seraient introduits dans le LaAlO3 couche de commutation résistive, conduisant à la réduction de la résistance initiale de S2 [16]. Cependant, ces grands nombres de défauts dans les couches minces diélectriques de S2 pourraient être efficacement réduits (ou éliminés) par un traitement de recuit supplémentaire, conduisant à une résistance initiale élevée de S3 [17]. De plus, le traitement de recuit supplémentaire a amené des Cu-NC et des atomes de Cu diffusés dans le LaAlO3 des films diélectriques, ce qui augmenterait encore le champ électrique local et entraînerait une faible tension de formation de S3 [18].
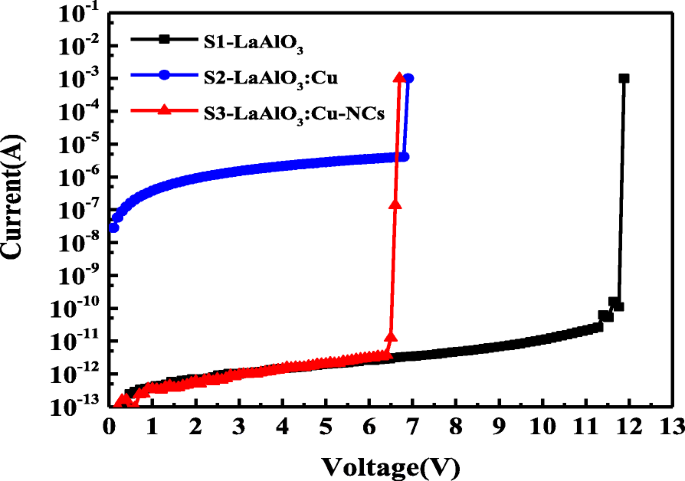
Processus de formation des trois types de RRAM à base de La
Courant-tension bipolaire typique (I –V ) des courbes d'environ 100 cycles de balayage en courant continu (CC) pour les trois types de dispositifs RRAM à base de La (taille de zone de 50 μm × 50 μm) sont obtenues sur la Fig. 5a–c. La tension de test (0 à - 1,5 V et - 1,5 à 0 V pour le processus de réinitialisation ; 0 à 5 V et 5 à 0 V pour le processus de réglage) est polarisée sur le TE (Cu) tandis que le BE (Pt) est mis à la terre . Bien que trois dispositifs RRAM basés sur La affichent 100 cycles consécutifs de comportement RS bipolaire reproductible, il existe de grandes différences entre eux. Tout d'abord, par rapport à S2 et S3, l'échantillon non dopé S1 est plus facile à endommager pendant les opérations cycliques d'initialisation-réinitialisation avec la tension d'arrêt de réinitialisation (V arrêter ) de − 1.5 V (comme indiqué dans l'insertion de la Fig. 5a), ce qui indique que le V maximum arrêter de S1 est inférieur à ceux de S2 et S3. Compte tenu de cela, un V relativement faible arrêter de − 1,4 V est utilisé dans le cas de l'échantillon S1. Une autre différence est que le I –V les courbes de S1 et S2 montrent des fluctuations anormales (montée et descente) au cours du processus de réglage, ce qui est assez différent du I lisse –V courbes de S3. Ce phénomène est étroitement lié au reste de certains filaments conducteurs (CF) dans le LaAlO3 non dopé (ou dopé mais non recuit) films diélectriques après le processus de réinitialisation. De plus, comparé à S1 et S2, S3 a I –V courbes montrant plus de cohérence et une distribution plus petite des tensions de réglage/réinitialisation, ce qui implique que la stabilité des dispositifs RRAM peut être efficacement améliorée par un traitement de dopage et de recuit. Les figures 5d–f sont le test d'endurance (~ 100 cycles, lu à − 0,1 V) de S1–S3 extrait de la gauche de la figure 5a–c. Le rapport de résistance maximum de Cu/LaAlO3 /Pt dispositifs RRAM, à savoir, l'état de haute résistance maximum (HRS) à l'état de faible résistance minimum (LRS) peut être aussi élevé que 6 ordres de grandeur. Cependant, la grande fluctuation aléatoire des HRS de S1 et S2 entraîne une fenêtre marche/arrêt de très faible niveau (~ 10). Contrairement à S1 et S2, la fenêtre marche/arrêt de S3 est environ 100 fois plus grande que celle de S1 et S2, ce qui indique que la caractéristique de cohérence des dispositifs RRAM à base de La dopé Cu est effectivement améliorée après le recuit. Le traitement de recuit dans S3 provoque non seulement la diffusion des atomes de Cu autour de l'ensemble du LaAlO3 film mais forme également des Cu-NC dans le diélectrique. Ainsi, le champ électrique local a été amélioré; le caractère aléatoire de la formation/rupture des FC a été contrôlé et la distribution HRS (LRS) a été améliorée [19]. Les résultats ci-dessus suggèrent que l'idée d'intégrer une nanocouche de Cu dans la RRAM à base de La nécessite un certain degré de traitement thermique afin d'obtenir de meilleures performances de l'appareil.

un –c I bipolaire typique –V courbes et d –f le test d'endurance de S1, S2 et S3
La figure 6a montre la probabilité cumulée des résistances HRS et LRS (lue à − 0,1 V), et la figure 6b enregistre la probabilité cumulée des tensions de réglage et de réinitialisation. Sur la figure 6a, les valeurs moyennes (μ ) de LRS et HRS dans S1, S2 et S3 sont respectivement de 50,7 Ω et 1,59 MΩ, 100,6 Ω et 1,51 MΩ et 80,6 Ω et 1,95 MΩ. Cependant, le coefficient de variation (σ /μ ) de LRS et HRS varient considérablement par rapport aux valeurs moyennes à peu près similaires dans S1, S2 et S3. Parmi eux, S3 a la valeur σ/μ minimale (LRS − 0,74, HRS − 1,02), suivi de S2 (LRS − 1,33, HRS − 1,23), et le σ/μ de S1 est le pire (LRS − 1,22, HRS − 3,00). Comme le montre la figure 6b, les valeurs moyennes des tensions de réinitialisation/réinitialisation sont d'environ − 0,79 µV/2,36 µV, − 0,83 µV/2,49 µV et − 1,25 µV/2,59 µV pour les échantillons S1, S2 et S3 respectivement. L'écart type (σ ) des tensions de reset/set, qui sont utilisées pour évaluer la dispersion des paramètres, sont respectivement de 0,20/0,82 (S1), 0,23/1,16 (S2) et 0,13/0,45 (S3). On peut constater que de grandes variations de HRS, LRS, V définir , et V réinitialiser en S1 et S2 sont améliorés après recuit. Comparé à S1 et S2, celui dopé et recuit (S3) présente une meilleure uniformité, indiquant que S3 a la meilleure stabilité de fonctionnement parmi les trois. Comme mentionné ci-dessus, un grand nombre de défauts sont susceptibles d'être introduits dans S2, ce qui posera des problèmes de fiabilité et de stabilité des dispositifs. Pour S3, ces grands nombres de défauts sont éliminés par le processus thermique, et le caractère aléatoire de formation/rupture des CFs est réduit en raison de l'existence de Cu-NCs. Ainsi, une uniformité fine avec de petites variations dans les tensions de commutation et les valeurs de résistance sont obtenues dans S3.
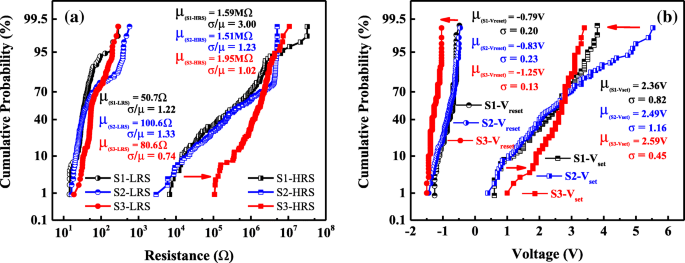
Probabilité cumulée de a HRS et LRS (lu à − 0,1 V) et b régler et réinitialiser les tensions
Les caractéristiques de rétention des trois types de dispositifs RRAM à base de La sous une tension de lecture de − 0,1 V à température ambiante sont illustrées à la Fig. 7. Pendant le test de rétention, le Cu/LaAlO3 : les appareils Cu-NC/Pt présentent des performances de rétention stables pendant plus de 10 4 s à température ambiante avec un R presque constant HRS /R LRS rapport allant jusqu'à trois ordres de grandeur, conforme aux caractéristiques non volatiles des RRAM à base de La. Le rendement bipolaire à 10 cycles DC SET/RESET est mesuré pour évaluer la capacité de commutation de S1, S2 et S3. Comme le montre la figure 8, S3 a le meilleur rendement, suivi de S2, et S1 est le pire. Ce résultat montre qu'une couche de Cu intégrée est utile pour augmenter le rendement des RRAM à base de La, et le rendement des dispositifs peut être encore amélioré par un traitement thermique supplémentaire. De plus, on peut trouver sur la figure 8 que les rendements des dispositifs augmentent avec la diminution de la surface du dispositif. Ce phénomène indique que le mécanisme de commutation résistif de Cu/LaAlO3 /Pt Les dispositifs RRAM peuvent être étroitement liés à l'effet de la chaleur Joule, c'est-à-dire que la chaleur Joule participe à la formation/rupture des filaments conducteurs et semble être plus importante dans les dispositifs de plus petite taille.
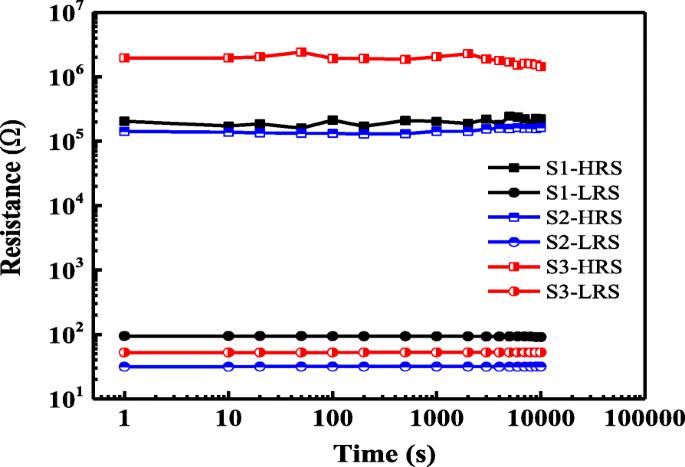
Comportements de rétention des périphériques RRAM basés sur La à température ambiante
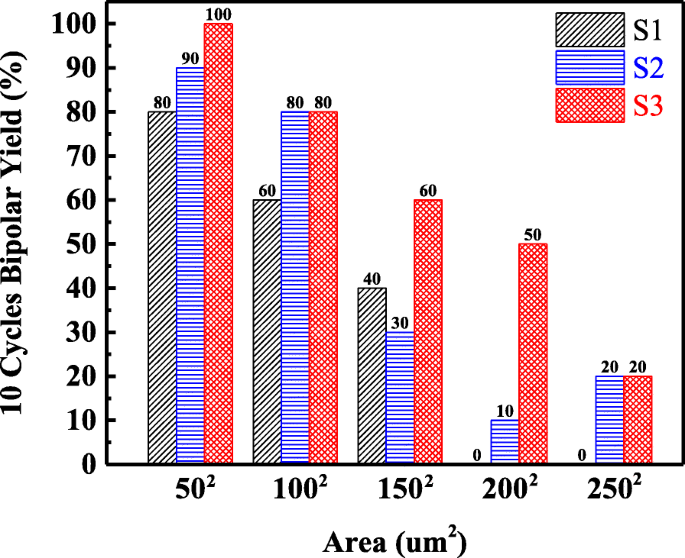
DC SET/RESET Rendement bipolaire à 10 cycles des périphériques RRAM basés sur La
Afin d'obtenir plus d'informations sur les RRAM à base de La à base de Cu-NC, une analyse plus approfondie a été axée sur le mécanisme de commutation de résistance de S3. Comme le montre la figure 9a, des tensions de réglage et de réinitialisation dans différentes directions sont appliquées dans le I –V mesure de S3. Les résultats des tests montrent que S3 a des comportements de commutation résistive à la fois unipolaires et bipolaires, indiquant que les RRAM à base de La à base de Cu-NC sont non polaires. Les chercheurs pensent que les comportements de commutation résistive non polaire (unipolaire) sont étroitement liés à la formation/rupture assistée par la chaleur Joule des CF [7]. Dans le processus de réinitialisation de la RRAM à base de La, un phénomène de dépassement de courant élevé est observé, puis l'effet de chauffage Joule est induit, conduisant à la fusion, au frittage ou à l'oxydation thermique des CF. La figure 9b montre le tracé double-logarithmique de I –V courbes et raccords linéaires de S3, et l'insert montre le ln(I /V )–V 1/2 courbe du processus défini. De toute évidence, le Je –V La relation dans LRS présente un comportement de conduction ohmique avec une pente d'environ 1, ce qui implique l'existence de CFs dans le diélectrique après le processus de prise. Cependant, le mécanisme de conduite de HRS est légèrement compliqué, et le I –V les courbes à HRS peuvent être divisées en trois droites avec trois pentes différentes. Dans la région de basse tension (<0,8 V, ligne orange), la pente de la ligne de montage est d'environ 1,33, ce qui est proche du mécanisme de transport ohmique. Avec l'augmentation de la tension (~ 0,8 à ~ 2 V, ligne verte), la pente de la ligne de montage augmente à 1,93 (I ~V 1.93 ), qui est conforme à la loi du carré de Child (I ~V 2 ). Dans la troisième région (> 2 V, ligne violette), la pente de la ligne d'ajustement continuera d'augmenter (par exemple, 2,86 dans ce cas), et le courant augmentera fortement lorsque V définir est atteint. Le mode de conduction du HRS, qui est composé de la région de transport ohmique et de la région de la loi de Child, est en bon accord avec le mécanisme classique de courant limité à charge d'espace (SCLC) [20, 21]. L'apparition du mécanisme de conduction SCLC indique la formation et la rupture du chemin de conduction local [22], qui est considéré comme le principal mécanisme RS de Cu/LaAlO3 :appareils Cu-NC/Pt. En outre, la conduction HRS s'avère également bien adaptée au mécanisme de conduction de Poole-Frenkel (l'insert). L'effet Poole-Frenkel est principalement causé par les porteurs excités par le champ électrique sautant à travers les états piégés [23], ce qui suggère qu'il existe encore un grand nombre de défauts dans le LaAlO3 films même après traitement de recuit.
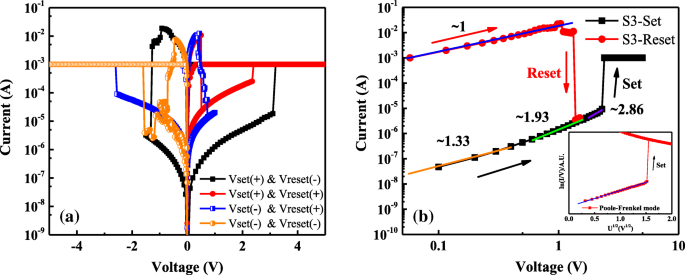
un Je –V mesure de S3 dans différentes directions de tension. b Tracé logarithmique double de I –V courbes et raccords linéaires de S3, et l'insert montre le ln(I /V )–V 1/2 tracé de l'ensemble du processus
La dépendance de S3 sur la surface de l'électrode (Fig. 10a) et la température (Fig. 10b) a été étudiée pour mieux comprendre le mécanisme RS. On peut voir sur la figure 10a que la résistance LRS est indépendante de la surface de l'électrode, tandis que la résistance HRS (et la résistance initiale) diminue avec l'augmentation de la surface du dispositif, ce qui indique que le mécanisme RS de S3 provient de la formation et de la rupture des FC. Sur la figure 10b, les résistances HRS diminuent avec l'augmentation de la température, montrant que l'état OFF de S3 peut être associé à un comportement semi-conducteur. En revanche, les résistances LRS augmentent avec l'augmentation de la température, indiquant une caractéristique métallique à l'état ON [24]. Selon la littérature, la relation entre la résistance du métal et la température est généralement étudiée par l'équation de R (T ) =R 0 [1 + α (T − T 0 )] [25]. Et l'ajustement linéaire bleu de la figure 10b détermine le coefficient de température (α ) à 1,03 × 10 −3 K −1 . Cette valeur est légèrement inférieure aux valeurs rapportées des nanofils de Cu dans d'autres littératures (2,5 × 10 −3 K −1 [26], 2,39 × 10 −3 K −1 [27]). En raison du fait qu'un grand nombre de défauts ont été introduits dans le LaAlO3 dopé Cu-NC films, un α inférieur valeur de Cu CFs est obtenue dans cet article.
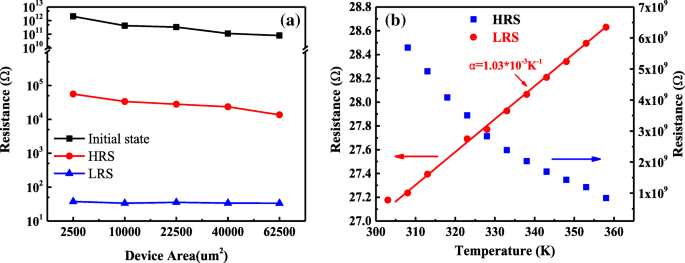
un Dépendance de la zone d'électrode du HRS et du LRS. b Dépendance à la température du HRS et du LRS
Par conséquent, une explication raisonnable a été proposée pour l'effet RS de Cu/LaAlO3 :appareils Cu-NC/Pt dans notre cas. La formation et la rupture de Cu CFs sont très susceptibles d'être médiées par la métallisation électrochimique (ECM) et l'effet de la chaleur Joule. La figure 11 montre des diagrammes schématiques du mécanisme RS de Cu/LaAlO3 :dispositifs Cu-NC/Pt dans (a) état initial ; (b), (c) Définir le processus ; (d) état ON ; et (e) Processus de réinitialisation. Lorsqu'une tension positive est appliquée à TE (Cu), une réaction d'oxydation, qui est décrite comme Cu → Cu 2+ + 2e − , se produit sur le matériau électrochimiquement actif (Fig. 11b). Sous l'action du champ électrique, le mobile Cu 2+ les cations migrent vers BE (Pt) via LaAlO3 film, et une réaction de réduction de Cu 2+ + 2e − → Cu se produit à la cathode (Fig. 11c). Il convient de noter qu'il y a des Cu-NCs et des atomes de Cu diffusés dans les diélectriques à base de La de S3, qui sont les voies naturelles pour la formation de Cu CFs. Ainsi, les atomes de métal Cu précipités en continu auront tendance à croître le long de ces voies naturelles et finiront par atteindre le TE pour former un canal conducteur (Fig. 11d). Lorsque la polarité de la tension appliquée est inversée, le processus de dissolution, qui est étroitement lié à l'effet électrochimique et à l'effet de chaleur Joule, se produit quelque part le long du filament, entraînant une rupture presque complète des CF et de l'appareil dans l'état OFF (Fig. 11e ).
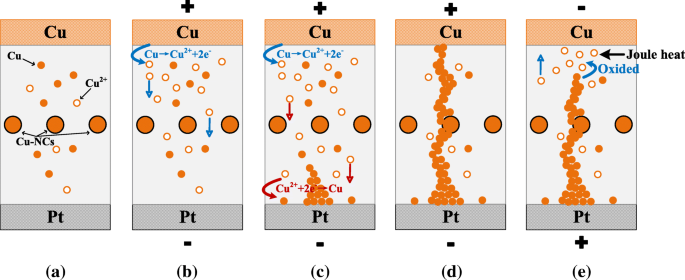
Schémas de principe du mécanisme RS de Cu/LaAlO3 :dispositifs Cu-NC/Pt en a Etat initial; b , c définir le processus ; d état ON ; et e processus de réinitialisation
Conclusion
En résumé, une méthode dopée au métal est introduite pour améliorer les performances des dispositifs RRAM basés sur La. Les améliorations évidentes des caractéristiques de commutation résistive, y compris une tension de formation inférieure, un rapport marche/arrêt plus élevé, une meilleure uniformité électrique et un rendement supérieur du dispositif, sont corroborées par le I –V résultats de mesure de l'échantillon dopé au Cu et recuit. Les résultats des analyses XPS et MET ont confirmé que les améliorations des performances de commutation pouvaient être attribuées à la diffusion d'atomes de Cu et à la formation de nanocristaux de Cu (Cu-NC) après le processus de recuit. D'autres études révèlent que le mécanisme de commutation résistif de Cu\LaAlO3 :Les dispositifs Cu-NC\Pt peuvent être attribués à la formation et à la rupture de filaments conducteurs de Cu, ce qui est étroitement lié au mécanisme SCLC et à l'effet de chauffage Joule. Cette étude démontre une méthode réalisable pour contrôler les comportements de commutation résistive des RRAM en incorporant des nanocristaux de Cu, et davantage de travaux doivent être effectués pour comprendre le mécanisme physique et les lois inhérentes des RRAM à base de La.
Disponibilité des données et des matériaux
Les ensembles de données soutenant les conclusions de ce manuscrit sont inclus dans le manuscrit.
Abréviations
- ALD :
-
dépôt de couche atomique; RRAM
mémoire vive résistive; CN
nanocristaux; M-I-M
métal-isolant-métal; RS
commutation résistive; Haut-k
constante diélectrique élevée; RS
commutation résistive; ÊTRE
électrode inférieure; RTA
recuit thermique rapide; TE
électrode supérieure; XPS
Spectroscopie photoélectronique par rayons X; DC
courant continu; CF
filaments conducteurs; RH
état de haute résistance; LRS
état de faible résistance ; SCLC
charge d'espace courant limité
Nanomatériaux
- 5 impacts que l'IoT aura sur la fabrication
- Les appareils SAW ultra-compacts de Murata répondent aux besoins de la 5G
- La menace croissante de l'IoT compatible Wi-Fi
- Connecter l'IoT – L'opportunité du bas débit
- Le rôle de l'IoT dans les soins de santé pendant le Covid-19
- Découvrir l'angle mort de l'IoT dans un monde post-pandémique
- Comment le bon effet final robotique impacte les performances robotiques
- Les défis du test logiciel des appareils IOT
- La performance efficace du moulage par injection rapide



