Photoconductivité interbande des points quantiques métamorphiques InAs/InGaAs dans la fenêtre 1,3–1,55 μm
Résumé
Propriétés photoélectriques du métamorphique InAs/In x Ga1 − x Les nanostructures sous forme de points quantiques (QD) ont été étudiées à température ambiante, en utilisant des spectroscopies de photoconductivité (PC) et de photoluminescence, des mesures électriques et une modélisation théorique. Quatre échantillons avec une stoechiométrie différente de In x Ga1 − x Au fur et à mesure de la croissance de la couche de revêtement :teneur en indium x était de 0,15, 0,24, 0,28 et 0,31. InAs/In0.15 Ga0,85 La structure QD s'est avérée photosensible dans la gamme des télécommunications à 1,3 μm. Comme x augmente, un redshift a été observé pour tous les échantillons, la structure avec x = 0,31 s'est avéré sensible près de 1,55 μm, c'est-à-dire à la troisième fenêtre de télécommunication. Simultanément, seule une légère diminution du QD PC a été enregistrée pour une augmentation de x , confirmant ainsi une bonne photoréponse comparable à celle de In0.15 Ga0,75 En tant que structures et des nanostructures QD à base de GaAs. De plus, la réduction du PC est en corrélation avec la réduction similaire de l'intensité de la photoluminescence. En simulant théoriquement le système d'énergie quantique et la localisation des porteurs dans les QD, nous avons mieux compris le mécanisme du PC et avons pu suggérer les raisons de la réduction du photocourant, en les associant à un comportement particulier des défauts dans un tel type de structures. Tout cela implique que les QD métamorphiques avec un x élevé sont des structures valides pour les dispositifs optoélectroniques infrarouges sensibles à la lumière.
Contexte
InAs/In x métamorphique Ga1 − x Comme les nanostructures QD ont suscité beaucoup d'intérêt au cours de la dernière décennie en raison de nombreux avantages [1,2,3,4,5,6,7]. Leur caractéristique la plus intéressante est qu'en faisant croître les QD sur un tampon métamorphique InGaAs (MB), on peut obtenir une réduction significative de l'énergie de transition entre les niveaux QD [8] par rapport aux structures QD In(Ga)As/GaAs conventionnelles. . Cela se produit en raison de la diminution de la bande interdite InAs QD en raison de la réduction du mésappariement de réseau entre les QD InAs et le tampon InGaAs et, par conséquent, la contrainte dans les QD [9,10,11]. Ainsi, l'application d'un MB comme matériau de confinement permet de décaler la valeur de la longueur d'onde d'émission plus profondément dans la gamme infrarouge (IR), en particulier dans les fenêtres de télécommunication à 1,3 et 1,55 μm, tout en maintenant un rendement élevé [4, 12, 13]. De plus, les QD métamorphiques ont montré des propriétés intéressantes telles que (i) une densité QD élevée [14], (ii) la possibilité d'ajuster largement les niveaux de QD et de couche mouillante (WL) [10, 15], et (iii) de bonnes performances de éléments actifs dans les dispositifs électroluminescents [16]. Cependant, les récentes enquêtes sur les niveaux profonds dans les QD métamorphiques ont montré que, malgré InAs/In0.15 Ga0,85 En tant que structures QD ayant une densité totale de défauts proche de la couche QD comparable à celle des QD pseudomorphes InGaAs/GaAs, des structures métamorphiques avec un x plus élevé ont démontré des densités de défauts plus élevées [17, 18].
Les structures métamorphiques InAs QD ont trouvé des applications réussies dans la conception et la fabrication de dispositifs photoniques IR et sensibles à la lumière, tels que les lasers [19, 20], les sources à photon unique [3, 7, 21, 22] et les cellules solaires [23 ,24,25]. Les photodétecteurs In(Ga)As QD basés sur des transitions interbandes et intersous-bandes sont actuellement activement étudiés pour une détection améliorée du proche IR à l'IR à ondes longues en raison de leur réponse à l'irradiation à incidence normale [26,27,28,29,30] . Par exemple, les transitions intersous-bandes des électrons entre les niveaux confinés quantiques et les états continus peuvent être conçues en incorporant des QD InAs dans des couches InGaAs [29,30,31,32], car cette conception permet de régler la longueur d'onde du pic de détection, pour contrôler la réponse par un biais appliqué de l'extérieur et pour réduire le courant d'obscurité [33, 34]. À ce jour, il n'y a pas d'articles sur la mise en œuvre de structures QD métamorphiques dans des photodétecteurs.
Le rôle clé pour le développement de ce domaine est la préservation d'une efficacité d'émission et d'une photosensibilité élevées des structures QD métamorphiques qui doivent être au moins comparables à celles des structures QD InAs/GaAs conventionnelles [1, 5, 35]. De nombreuses études ont été menées dans les domaines fondamentaux et applicatifs pour développer la conception des structures [6, 14, 21], améliorer les propriétés photoélectriques [5, 13] et contrôler/réduire les défauts liés aux déformations dans les hétérostructures [4, 36, 37].
Par conséquent, InAs/In x Ga1 − x Les nanostructures QD métamorphiques sont des nanostructures intéressantes, qui permettent d'avoir une émission ou une photoréactivité dans les gammes IR 1,3- et 1,55-μm [1,2,3,4,5,6,7]. De plus, nous avons signalé plus tôt que la verticale InAs/In0.15 Ga0,75 Les structures QD peuvent maintenir une photosensibilité comparable à celles à base de GaAs [5]. Cependant, de telles structures métamorphiques sont rarement étudiées dans les mesures photoélectriques avec une géométrie latérale, où le photocourant passe par le transport dans le plan de porteurs à travers des canaux entre deux contacts supérieurs. Généralement, les couches QD ainsi que les WL associés forment ces canaux de conductivité dans les structures à base de GaAs conçues pour la géométrie latérale [38]. En raison de ce type particulier de conductivité, on pense que les photodétecteurs QD avec transport latéral ont un potentiel de photoréactivité élevée [39, 40]. Une étude approfondie des nanostructures métamorphiques InAs/InGaAs QD dans la configuration latérale peut fournir une connaissance fondamentale du mécanisme de photoconductivité (PC) et de l'efficacité du transport de porteurs en plaine. Dans notre article récent consacré aux défauts dans les structures QD métamorphiques [17], nous avons rapporté des mesures latérales de PC à basse température, en ne considérant que les bords des spectres IR provenant des défauts. Cependant, nous pensons qu'une caractérisation appropriée et une étude fondamentale de la structure à température ambiante peuvent fournir des informations précieuses pour de nouvelles améliorations de nouveaux dispositifs photosensibles tels que les photodétecteurs proche infrarouge, les réseaux linéaires et les matrices de caméra, en mettant en œuvre des QD métamorphiques.
Dans le présent travail, nous avons étudié les propriétés photoélectriques dans le plan du métamorphique InAs/In x Ga1 − x En tant que nanostructures QD développées par épitaxie par faisceau moléculaire avec différentes compositions en x , en utilisant des spectroscopies PC et photoluminescence (PL), des mesures électriques latérales et des calculs de modélisation. En particulier, nous nous sommes concentrés sur l'observation d'un possible redshift de la photoréponse de la couche QD vers l'IR au-delà de 1,3 μm tout en préservant la photosensibilité à l'identique pour In0,15 Ga0,85 Structures photosensibles As et GaAs QD. Une photosensibilité élevée dans la plage de longueurs d'onde du proche infrarouge à température ambiante indique que ces nanostructures peuvent être utiles non seulement pour les appareils basés sur des transitions interbandes, mais également pour les photodétecteurs intersous-bandes fonctionnant au-delà de 10 μm.
Méthodes
Préparation et description de l'échantillon
Les structures étudiées représentées schématiquement sur la figure 1 ont été développées par épitaxie par faisceau moléculaire. Tout d'abord, un substrat GaAs semi-isolant (100) a été recouvert d'un tampon GaAs de 100 nm d'épaisseur à 600 °C, suivi du dépôt d'un InGaAs MB non dopé d'une épaisseur de 500 nm à 490 °C. Ensuite, après l'interruption de croissance préalable de 210 s pour refroidir le substrat, 3,0 ML (monocouches) d'InAs ont été cultivés à 460 °C. Enfin, ces QD auto-assemblés ont été recouverts de 20 nm d'In x non dopé Ga1 − x Comme avec la même stœchiométrie MB. Quatre échantillons avec une stoechiométrie différente de In x Ga1 − x Comme la couche de revêtement a été fabriquée :dans le contenu x était de 0,15, 0,24, 0,28 et 0,31.
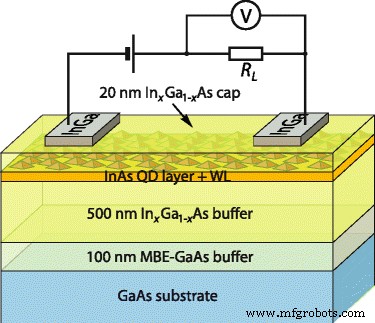
Couleur en ligne. Schéma du métamorphique InAs/In x Ga1 − x Comme structures QD et leur connexion pour les mesures photoélectriques
Modélisation théorique
Pour la conception de la structure métamorphique ainsi que la compréhension du profil énergétique, les calculs du système énergétique quantique composé des QD In(Ga)As, du MB non dopé et de la couche de protection ont été effectués à l'aide du logiciel Tibercad [41] que nous avons démontré pour être adéquat pour simuler les propriétés optiques des nanostructures semi-conductrices de faible dimension [2, 15, 42].
Nous considérons un InAs QD avec une forme et des tailles coniques tronquées tirées de données expérimentales de microscopie à force atomique [14]; nous incluons la présence de InAs WL, dont les paramètres dépendent du In x Ga1 − x En tant que propriétés de la couche métamorphique [15].
Tout d'abord, les calculs de déformation de la structure sont effectués, en calculant les composantes du tenseur de déformation du QD, induites par le décalage f QD entre le QD et le MB, défini comme
$$ {f}_{\mathrm{QD}}=\left[{a}_{\mathrm{InAs}}\hbox{--} {a}_{\mathrm{MB}}(x)\right ]/{a}_{\mathrm{MB}}(x) $$ (1)où un Mo (x ) est le paramètre de réseau de In x Ga1 − x Comme MB et a InAs est le paramètre de réseau de InAs. Ensuite, les profils de bande pour les QDs et les couches d'enrobage dépendent des potentiels de déformation des matériaux concernés (InAs pour les QDs et WLs et InGaAs relaxé pour MB).
Enfin, l'équation de Schrödinger
$$ \boldsymbol{H}\psi =E\psi $$ (2)est résolu dans l'approximation de la fonction enveloppe par une approche de masse effective à bande unique pour les électrons et une approche à 6 bandes k•p pour les trous, où l'hamiltonien 3D est
$$ \widehat{H}=-\frac{\upeta^2}{2}{\nabla}_{\mathbf{r}}\left(\frac{1}{m\left(E,\mathbf{ r}\right)}\right){\nabla}_{\mathbf{r}}+V\left(\mathbf{r}\right), $$ (3)avec V (r ) étant le potentiel 3D.
Une telle approximation est considérée comme satisfaisante lors du calcul de l'état fondamental QD [2]. On obtient ainsi des niveaux au sol pour les électrons et les trous lourds, ainsi que leurs densités de probabilité. Les énergies d'émission de photoluminescence ont été dérivées en prenant la différence d'énergie entre les niveaux confinés pour les électrons et les trous lourds, réduite de 20 meV pour prendre en compte les effets excitoniques.
Une description plus détaillée des calculs du modèle peut être trouvée dans la réf. [2].
Caractérisation photoélectrique
Pour les mesures photoélectriques latérales, deux contacts de surface eutectiques InGa ont été déposés sur des morceaux de 5 × 2 mm des structures. I linéaire mesuré –V les caractéristiques données sur la Fig. 2 ont confirmé l'ohmicité du contact. Le courant traversant les échantillons a été mesuré par un multimètre Siglent SDM3055, en utilisant une technique à courant continu standard [43, 44] sous forme de chute de tension à travers une résistance de charge en série R L de 1 MΩ, ce qui était bien inférieur à la résistance de l'échantillon. Le photocourant a été excité par une lampe halogène de 250 W dispersée avec un monochromeur à prisme, et les spectres PC ont été enregistrés dans la plage de 0,6 à 1,6 eV [44, 45, 46]. Les spectres ont été normalisés au nombre de quanta d'excitation de la source lumineuse. Les spectres PL ont été obtenus en utilisant un laser à 532 nm comme source d'excitation avec une densité de puissance de 5 W/cm 2 . Toutes les mesures ont été effectuées à température ambiante (300 K).

Couleur en ligne. Je –V caractéristiques des InAs/In x Ga1 − x En tant que structures avec x = 0.15 (a ), 0,24 (b ), 0,28 (c ) et 0,31 (d ) pour l'obscurité (noir) et sous un éclairement de 350 μW/cm 2 (couleur) aux énergies du pic du spectre PL (excitation QD) et 1,3 eV (absorption effective en InGaAs). Encarts :dépendances du photocourant sur la tension de polarisation
Résultats et discussion
Spectres PC des métamorphiques étudiés InAs/In x Ga1 − x Les structures QD à température ambiante sont présentées sur la Fig. 3 avec les bandes PL, qui montrent les transitions optiques entre les états fondamentaux QD. Les intensités relatives et les positions des bandes PL sont également illustrées à la Fig. 4b. Les caractéristiques dues aux QD, aux couches de confinement d'InGaAs et aux couches inférieures de GaAs sont observées sur les courbes PC. Le signal de photocourant aux énergies inférieures aux débuts de la bande PL pourrait être lié aux défauts de structure détectés précédemment [17].

Couleur en ligne. Spectres PC du métamorphique InAs/In x Ga1 − x En tant que structures à température ambiante et un biais de 11 V pour x = 0.15 (a ), 0,24 (b ), 0,28 (c ) et 0,31 (d ). Les intensités d'excitation des courbes noire, rouge et bleue à 1,3 eV correspondent à 88, 350 et 1400 μW/cm 2 , respectivement. Les spectres PL en unités arbitraires sont donnés pour le positionnement énergétique des transitions d'état fondamental QD. Les flèches verticales marquent les bandes interdites InGaAs (ε g ) calculé selon Paul et al. [48] et les positons spectrales, où les dépendances du PC vis-à-vis de l'intensité d'excitation ont été mesurées (indiquées sur la Fig. 5)

Couleur en ligne. Calculs de modélisation pour le métamorphique InAs/In x Ga1 − x En tant que structures QD :a profils de bande dans les structures avec différents x le long de l'axe de croissance ; b les bandes QD PL réelles et leurs positions de crête calculées (verticales en pointillés) ; et c densités de probabilité des électrons confinés et des trous pour InAs/In0.15 Ga0,85 En tant que QD. Tous les calculs des structures modélisées ont été effectués pour 300 K
Le métamorphique InAs/In0.15 étudié Ga0,85 La structure QD s'est avérée photosensible dans la gamme des télécommunications à 0,95 eV (1,3 μm) (Fig. 3a). Comme x augmenté, un redshift a été observé pour tous les échantillons :la structure avec x = 0,31 s'est avéré sensible près de 0,8 eV (1,55 μm) (Fig. 3d), c'est-à-dire à la troisième fenêtre télécom [47]. Le décalage est lié à la réduction du décalage de maille entre les matériaux de InAs QD et In x Ga1 − x Comme tampon avec une augmentation de x et, par conséquent, une diminution de la contrainte dans les QDs. Cela conduit à un rétrécissement de la bande interdite InAs QD et, à son tour, au décalage vers le rouge de la bande PL ainsi qu'à l'apparition de la photoréponse vers l'IR [1,2,3,4,5,6, 19, 35].
Simultanément, seule une légère diminution du signal du photocourant QD a été enregistrée, confirmant ainsi le maintien d'une bonne photoréactivité, comparable à celle du In0.15 Ga0,75 Comme exemple. Comme nous l'avons vu récemment [5], les structures QD métamorphiques avec x = 0.15 montrent une photoréponse très similaire à celles des nanostructures pseudomorphes InAs/GaAs QD. De plus, la réduction du PC est en corrélation avec celle du PL, comme on peut le voir sur la figure 3.
Un tel effet pour nos échantillons s'est avéré le plus notable sur la figure 2, où le I –V les dépendances à l'obscurité et sous éclairage à différents points spectraux caractéristiques de la tension de polarisation sont montrées, ainsi que les dépendances du photocourant dans les médaillons. Comme sur la figure 3, la valeur du photocourant implique uniquement la partie photoinduite du courant obtenue à partir du courant total sous éclairage en soustrayant la valeur du courant d'obscurité. Ces points spectraux sont les maximums de la bande PL et 1,3 eV, où se produit une absorption efficace de bande à bande dans InGaAs MB. Ainsi que pour le noir I –V caractéristiques, ces dépendances sont de type linéaire dans l'erreur expérimentale.
La meilleure photoréponse a été mesurée dans la structure avec la teneur minimale en In dans les couches de confinement. Il avait également le courant d'obscurité le plus faible. La valeur du photocourant au niveau d'excitation appliqué (350 μW/cm 2 ) dans le InAs/In0.15 Ga0,85 Comme la structure était deux à trois fois supérieure au courant d'obscurité lorsque MB était pompé. La photoréponse à l'excitation QD était comparable au courant d'obscurité; cependant, il faut considérer que nos structures n'avaient qu'une seule couche QD. La fabrication des structures QD multicouches conduirait sûrement à une augmentation significative de la photoréponse IR. Autres structures avec un x plus élevé a révélé des signaux de photocourant plus faibles; les amplitudes détectées aux deux points spectraux étaient approximativement d'un ordre inférieur aux valeurs de courant d'obscurité dans une large gamme de tension appliquée. La photoréponse la plus faible a été trouvée pour InAs/In0.31 Ga0.69 En tant que structure avec le contenu maximal de MB In.
Très probablement, cette diminution de la photoréactivité est liée à une augmentation de la densité de défauts MB avec x , qui a été déterminé précédemment pour ces structures, en utilisant une spectroscopie à courant stimulé thermiquement à niveau profond [17], qui était bien corrélée avec l'analyse structurelle de telles nanostructures [1]. Nous avons signalé que le InAs/In0.15 Ga0,85 Comme la structure QD avait une densité de défauts totale proche de la couche QD comparable à celle d'InGaAs/GaAs, alors que d'autres structures avec des teneurs en In plus élevées présentaient des densités de défauts plus élevées comme les complexes connus de défauts ponctuels liés à GaAs EL2, EL6, EL7, EL9 et EL10 près de la couche QD et trois niveaux attribués à des défauts étendus se propageant à travers le tampon.
En ce qui concerne la forme du spectre (Fig. 3), au-dessus de l'excitation QD, l'absorption de la lumière et, par conséquent, la génération de porteurs se produisent principalement dans le MB à des énergies supérieures à la bande interdite de la couche de confinement InGaAs ε g , quelles valeurs pour différents x ont été estimées par une formule empirique [48]. Cependant, il est à noter qu'une augmentation de l'énergie des photons au-dessus de ε g conduit à une légère diminution de la photoréponse. Naturellement, cela confirme que les QD métamorphiques, bien qu'étant des centres de recombinaison efficaces [1, 2, 12, 22], sont des contributeurs plus efficaces au photocourant que MB [5, 6, 23].
Pour comprendre le mécanisme PC de cette particularité, il faut regarder la figure 4a, où nous montrons les profils de bande QD calculés le long de la direction de croissance pour nos échantillons. Les calculs sont validés par le résultat des niveaux d'énergie quantique pour les électrons et les trous :les énergies d'émission PL attendues sont en accord avec la transition d'état fondamental PL QD mesurée expérimentalement (Fig. 4b). Sur la figure 4c, nous montrons les densités de probabilité simulées pour les électrons et les trous confinés, obtenues par les fonctions d'onde porteuses calculées avec la modélisation Tibercad, qui indiquent un niveau de localisation plus élevé pour les trous lourds par rapport aux électrons.
Afin de contribuer au signal photocourant, les paires électron-trou générées par l'absorption interbande QD doivent s'échapper des QD par émission thermique. Dans une étude précédente [49], il a été établi que dans les QD métamorphiques, les électrons et les trous lourds s'échappent simultanément des QD en tant que paires corrélées. De plus, il a également été démontré que l'énergie d'activation pour un tel processus correspond à la somme des énergies d'activation pour les deux particules [50].
En étudiant la trempe thermique de l'émission PL des QD métamorphiques [10, 51], nous avons prouvé que ces énergies d'activation sont égales à la somme de la distance énergétique des niveaux WL et des états QD et vont de 250 meV pour x = 0,15 jusqu'à 150 meV pour x = 0.31. Comme largement discuté dans la Réf. [51], ces valeurs provoquent une forte extinction de l'émission PL à température ambiante via l'échappement thermique des porteurs confinés.
Sur cette base, nous pouvons en déduire que les porteurs excités dans les QD peuvent s'échapper thermiquement vers WL et MB :là, les électrons et les trous lourds sont séparés par la courbure de la bande au voisinage de QD (Fig. 4a), ce qui favorise le piégeage des trous vers les QD et, tout en étant une barrière pour les électrons, supprime ainsi efficacement leur recombinaison radiative. En conséquence, les trous lourds sont concentrés à la périphérie de QD (Fig. 4c), tandis que les électrons sont libres de se déplacer le long du puits de potentiel de WL et MB contribuant à la conductivité. Il est à noter que dans la Réf. [49], il est discuté que, bien que corrélés au cours du processus d'échappement, les porteurs ne peuvent pas être considérés comme des excitons à température ambiante; désormais, ils peuvent être facilement séparés par le pliage de la bande au voisinage des QD.
Sinon, lors de l'excitation du MB, des trous de non-équilibre sont générés dans les couches de confinement et se recombinent avec les électrons. Il convient de mentionner ici que le WL est connu pour être un canal de conductivité pour les nanostructures à base de GaAs [52] et, dans nos structures latérales conçues avec des contacts de surface, il n'y a pas d'hétérojonction, de sorte que les porteurs sont efficacement collectés près du plan de surface.
Dans la Fig. 3, la chute du signal PC juste au-dessus de ε g s'est transformé en une augmentation à des énergies plus élevées, par exemple, au-dessus de 1,3 ou 1,1 eV pour un échantillon avec x de 0,15 ou 0,31, respectivement. Cela a probablement été causé par l'absorption optique plus proche de la surface et de la couche QD, impliquant ainsi des pièges moins profonds. Comme établi pour ces structures par spectroscopie à courant stimulé thermiquement et spectroscopie transitoire de niveau profond [17, 18], les pièges à électrons plus profonds sont principalement situés dans la couche InGaAs MB, tandis que les moins profonds sont concentrés près de la surface (par rapport à ces échantillons, près de la couche QD). Les électrons piégés dans les pièges moins profonds peuvent plus facilement s'échapper vers la bande de conduction à température ambiante. Ainsi, les électrons libres près de la couche QD sont plus mobiles que ceux excités plus profondément dans le MB et, par conséquent, contribuent plus au transfert de charge. De plus, les électrons, générés près de la surface, peuvent être transférés librement vers le canal de conductivité WL.
Une baisse similaire du photocourant suite à une augmentation au-dessus de la bande interdite GaAs (près de 1,4 eV) a été observée. Cet effet pourrait être dû à la génération de porteurs à proximité de l'interface InGaAs/GaAs, qui est connue pour avoir une densité plus élevée d'états défectueux étant des pièges et des centres de recombinaison.
La contribution relative des différentes transitions optiques à la photoréponse de la structure variait avec l'intensité de pompage. Ceci est mieux observé sur la Fig. 5, qui montre les valeurs du photocourant en fonction de l'intensité d'excitation à différents points spectraux caractéristiques :l'apparition de la bande PL (excitation résonante de l'ensemble QD) ou l'absorption bande à bande efficace dans InGaAs (1,3 eV) et GaAs (1,5 eV).
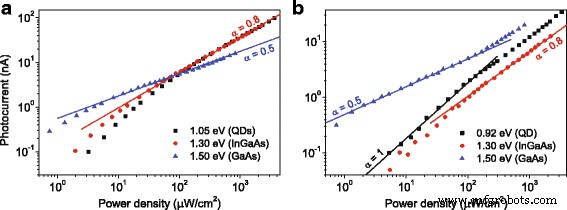
Couleur en ligne. Photocourant vs intensité d'excitation pour InAs/In x Ga1 − x En tant que structures avec a x = 0.15 et b 0,31. Les lignes sont l'ajustement par les fonctions f (x ) ~ x α
Les structures avec des contenus en In différents dans les couches de confinement ont démontré des dépendances similaires à des gammes spectrales équivalentes. Ainsi, l'excitation bande à bande dans GaAs (1,5 eV) montre une dépendance quadratique à la plupart des valeurs d'intensité. Ceci est typique de la recombinaison bande à bande des porteurs de charge hors équilibre, par exemple lorsqu'ils sont fortement prédominants sous les porteurs à l'équilibre [53] :ceci est prévisible dans nos structures non dopées. Les dépendances dans le cas de l'excitation dans les couches de confinement QD et InGaAs sont très similaires mais différentes de celles pour GaAs. Ils sont linéaires aux faibles intensités d'excitation et deviennent sublinéaires aux intensités plus élevées. Ce comportement indique évidemment la recombinaison des porteurs impliquant les centres de Shockley-Read :la dépendance linéaire devient sublinéaire, car certains des centres sont saturés à des taux de génération de porteurs plus élevés [54]. Ces résultats de mesures dépendantes de l'intensité indiquent clairement une génération efficace de porteurs de charge principaux à un taux de recombinaison relativement faible dans les couches d'enrobage QD et une densité beaucoup plus élevée de centres de recombinaison dans les couches de GaAs. Par exemple, lors de l'excitation QD dans des caractérisations similaires, les structures photosensibles InGaAs/GaAs QD ont montré une dépendance de l'intensité comme PC (Je ) ~ Je 0.25 , qui s'est produit en raison d'un taux élevé de recombinaison non radiative à travers des niveaux de défauts ainsi que d'une recombinaison radiative QD [40, 55]. Cependant, il convient de noter que la structure InGaAs/GaAs était multicouche avec sept couches QD.
A partir de ces mesures et de leur interprétation, quelques indications pour l'utilisation des QD métamorphiques pour la détection IR peuvent être mises en évidence :(i) lors de l'utilisation de x> 0,15, des conceptions avancées permettant de contrôler les défauts liés à la déformation devraient être utilisées, à l'instar de ce qui a été fait pour le développement des QD métamorphiques [19, 20, 37] ; (ii) des empilements multicouches de QD (avec un minimum de 10 couches) sont nécessaires pour obtenir un QD PC au-dessus du courant d'obscurité [27, 56]; et (iii) comme un confinement plus élevé des trous lourds est bénéfique pour le photocourant obtenu lors de l'excitation des QD, des conceptions avancées avec des barrières à plus grand espacement pour les trous lourds pourraient être envisagées [51, 57]. Par conséquent, ces résultats peuvent être très utiles pour la conception de QD métamorphiques visant la détection infrarouge et le développement de photodétecteurs QD métamorphiques.
Conclusions
Propriétés photoélectriques du métamorphique InAs/In x Ga1 − x Comme QD, les nanostructures ont été étudiées à température ambiante, en utilisant des spectroscopies PC et PL, des mesures électriques et des simulations de modèles théoriques. Le métamorphique étudié InAs/In x Ga1 − x Comme les nanostructures QD se sont avérées photosensibles dans les fenêtres de télécommunication à 1,3 (x = 0,15) et 1,55 μm (x = 0.31). Cependant, le QD PC ainsi que les efficacités PL des structures avec des teneurs en In plus élevées en MB ont été estimées inférieures et néanmoins comparables à celle de l'InAs/In0,15 Ga0,85 En tant que structure, qui a une sensibilité similaire aux structures QD InGaAs/GaAs. Cette réduction de la photoréactivité est liée à une augmentation de la densité de défauts MB avec x . De plus, grâce à des calculs de modélisation, nous avons fourni des informations sur le mécanisme PC dans le type de structures QD étudié. Tout cela implique que les QD métamorphiques avec un x élevé sont des structures valides pour les dispositifs optoélectroniques IR sensibles à la lumière, à condition que certains points de préoccupation soient résolus par l'optimisation de la conception de la nanostructure.
Abréviations
- ε g :
-
Bande interdite de la couche de confinement InGaAs
- E c et E v :
-
Énergie des bandes de conductivité et de valence
- IR :
-
Infrarouge
- Mo :
-
Tampon métamorphique
- ML :
-
Monocouche
- PC :
-
Photoconductivité
- PL :
-
Photoluminescence
- QD :
-
Point quantique
- R L :
-
La résistance de charge
- WL :
-
Couche mouillante
Nanomatériaux
- N,N-diméthylformamide régulant la fluorescence des points quantiques MXene pour la détermination sensible de Fe3+
- Source lumineuse à photon unique à 1,3 μm basée sur un point quantique à double couche InAs dans un micropilier
- Synthèse de points quantiques de carbone co-dopés en pyridinique N, S en tant qu'imitateurs d'enzymes efficaces
- Détection de l'excitation spatialement localisée dans les superréseaux à points quantiques InAs/InGaAs auto-organisés :un moyen d'améliorer l'efficacité photovoltaïque
- Points quantiques de bismuth dans des puits quantiques recuits GaAsBi/AlAs
- Effets bipolaires en photovoltage des hétérostructures à points quantiques métamorphiques InAs/InGaAs/GaAs :solutions de caractérisation et de conception pour les dispositifs sensibles à la lum…
- Une approche simple pour la synthèse de points quantiques de carbone fluorescent à partir d'eaux usées de tofu
- Synthèse de points quantiques de sulfure d'antimoine solubles dans l'eau et de leurs propriétés photoélectriques
- Un aperçu complet du bus de données :reliez les points !



